
電子ビームリソグラフィ(EBL)の紹介
電子ビームリソグラフィーとは?
電子ビームリソグラフィ(e-beam lithography; EBL)は、マスクレスリソグラフィの一種で、極短波長の集束電子を電子感応性フォトレジスト(レジスト)の表面に直接作用させて、設計パターンに一致したマイクロ・ナノ構造を形成するものです。 EBL装置は、超高解像度(限界サイズ10nm未満の図形転写)とフレキシブルなパターン形成(マスクなしの直接描画)という長所を持つが、露光効率が低く、制御が複雑なため、EBLはリソグラフィー用マスク、先端原理試作品、ナノスケール科学研究開発用として使用されることが多い。
開発の経緯
- 1958年、MITの研究者が高解像度の2次元グラフィック構造を生成するためのエッチングマスクを形成するために、電子誘導による炭素汚染を初めて使用したこと
- 電子ビーム露光は、1965年から100nmの構造を作るために使われている
- 1968 PMMAが電子線フォトレジストとして使用される。
- 1970 0.15μm音波デバイス(PMMA製
- 1972年:電子ビームリソグラフィーを用いたシリコン表面上の60x60nmのアルミニウム金属線断面図
1980年代には、光露光は一巡し、電子ビームリソグラフィが最も有望な代替技術であると広く信じられていたが、30年以上たった今でも、電子ビームリソグラフィは光露光に代わるものではない。しかし、30年以上経った現在でも、電子ビーム露光は光露光の代替技術にはなっておらず、2つの露光技術の発展には相互補完的なパターンが徐々に生まれ、このパターンは長く続くと考えられている。
理論的な基礎知識
光露光の解像度は光の波長によって制限されるため、光の波長の選択は、G線からI線、深紫外、極紫外へと連続的に短くなっていく過程を経てきました。
電子ビームは本来、荷電粒子であり、波動・粒子二元論によれば、波長が

電子ビーム露光装置
- ホットエレクトロン源は、カソード材料中の電子が十分な運動エネルギーを得て、電子銃の金属仕事関数のポテンシャル障壁を突破し、電子ビームを形成するために放出されることができるように十分な高温に加熱されたカソードです。
- 電界放出源は、電子がポテンシャル障壁をトンネル状に通過するように電界を強化して電子源を形成する。電子源からの電子ビームの収束と偏向は、電子レンズ、ダイヤフラム、バッフルなどの一連の装置からなる電子ビームカラムで行われます。電子はダイアフラムで整形され、電子レンズでビームスポットに収束され、偏向装置でベンチに照射される。

電子ビーム露光装置における重要な指標
- 最小バンドル径。これは、露光画像の最小サイズに直接影響する。加速電圧をできるだけ高くする ②絞りを小さくする ③ワーキングディスタンスを小さくする ④走査野を小さくする ⑤露光ステップを小さくする などの調整により、スポット径を小さくすることができます。
- 加速電圧です。一般に加速電圧は10~100kvと高いほど解像度が高く、露光による近接効果が少ないため、より厚いレジストを露光することができる。
- 電子ビームフロー。ビーム電流が大きいほど露光速度は速くなるが、最大露光速度は走査周波数によって制限され、ビーム電流が大きいほどビームスポットは大きくなる
- スキャニング速度です。スキャン速度が速いほど露光速度が速くなる、周波数で表すと(例:50MHz)
- スキャニングフィールドのサイズ。スキャンフィールドが広いため、露光画像のほとんどをスキャンフィールド内で露光することができ、スキャンフィールドスティッチングによるエラーを回避することができる
- また、テーブルの移動精度、レジスタの精度、フィールドスプライシングの精度など。
電子線照射法の分類
作業方法によって分割される
投影露光(要マスク)、直接露光(要マスクなし)
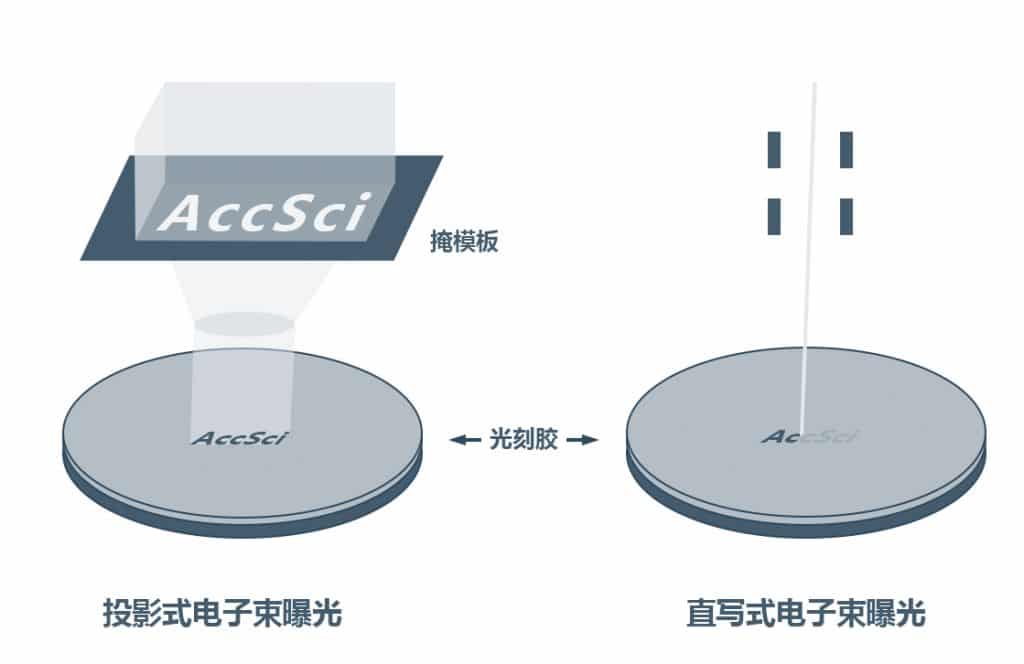
スキャン方式で分割
ラスタースキャンとベクタースキャンがある
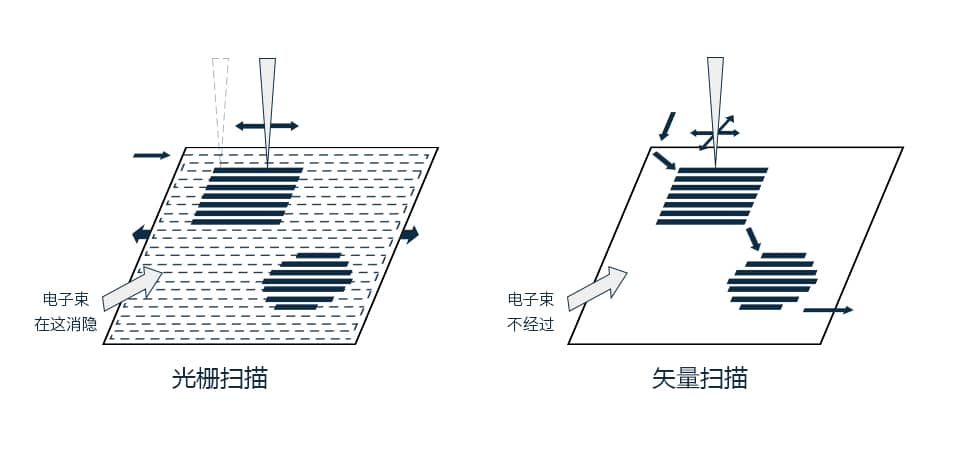
- ラスタースキャンガウス型の円形ビームを用い、電子ビームを走査野全体に点々と連続的に走査し、シャッター(ビームゲート)のオンオフを制御することで画像を露光する。ラスタースキャンの利点は、制御が簡単で偏向装置の制御が不要なことです。 デメリットは、生産効率が低いことです。 スキャンフィールドが小さいため、ワークテーブルの移動に連動して露光を完了させる必要があります。
- ベクタースキャンベクトル走査の利点は、露光が効率的であること、グラフィック領域のみを走査して露光するため、非グラフィック領域でのレンズの使用時間が短縮できること、可変矩形ビームが使用できることである。 デメリットは、固定された偏向を使用するラスタースキャンと異なり、ベクトルスキャンは偏向器を制御する必要があるため、制御システムが複雑であることです。
電子ビーム形状別
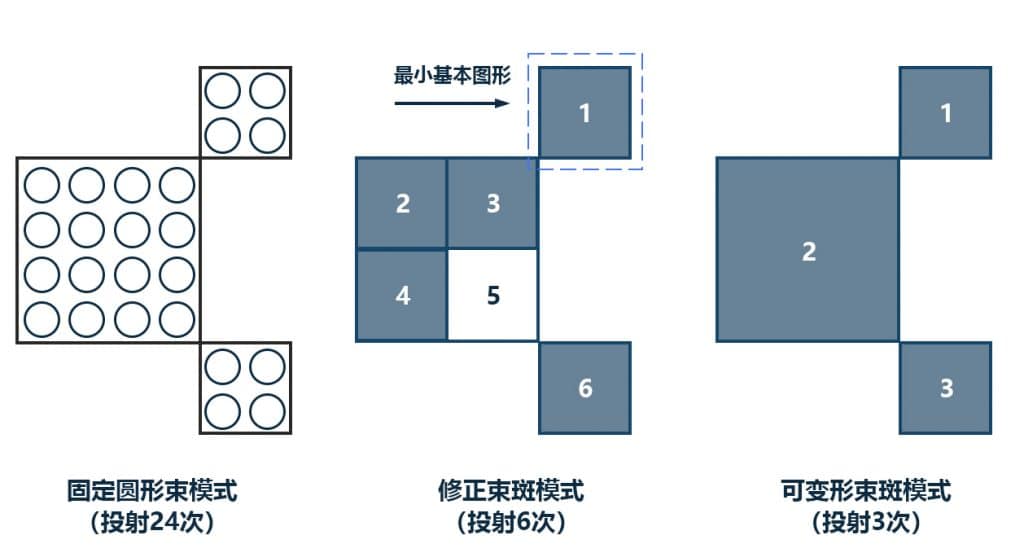
ベクトル走査モードでは、パターンの露光時間はビームスポットの投影数に関係します。ガウシアンビーム(円形ビーム)の固定スポットパターンでは、24回の投影を行う必要があります。
露光速度を速くするために、最小の基本パターンを電子ビームスポットの形状として、パターンを最小の基本パターンの組み合わせに分解することができます。この改良型ビームスポットモードでは、わずか6個の投影が必要です。
しかし、実際にはパターンが一定ではなく、基本的なビーム形状を頻繁に再設定する必要があるため、より柔軟な投射方法が求められます。パターンが多様な場面では、可変ビームパターンを利用することができます。下図に示すように、可変ビームパターンモードでは、電子ビームスポットを特定のパターンに調整することができ、基本的なビームスポット形状を変え、投影回数を3回に減らすことができます。
電子線フォトレジスト入門
フォトレジスト (フォトレジスト;photoresist)とは、紫外線、エキシマレーザー、電子線、イオンビーム、X線などの光源からの照射や放射線によって溶解度が変化するエッチング耐性薄膜材料です。
電子線フォトレジストは、通常、ポジ型フォトレジストとネガ型フォトレジストに分けられます。というように、フォトレジスト照射後の架橋反応や化学結合の切断をどちらが支配するかで分けることができます。フォトレジストのプラスとマイナスの特性は絶対的なものではありません通常の10倍の露光量で露光部のグルーが炭化し、現像時に残留する場合、例えば電子線ポジグルーPMMAの特性をネガグルーとして利用することができます。
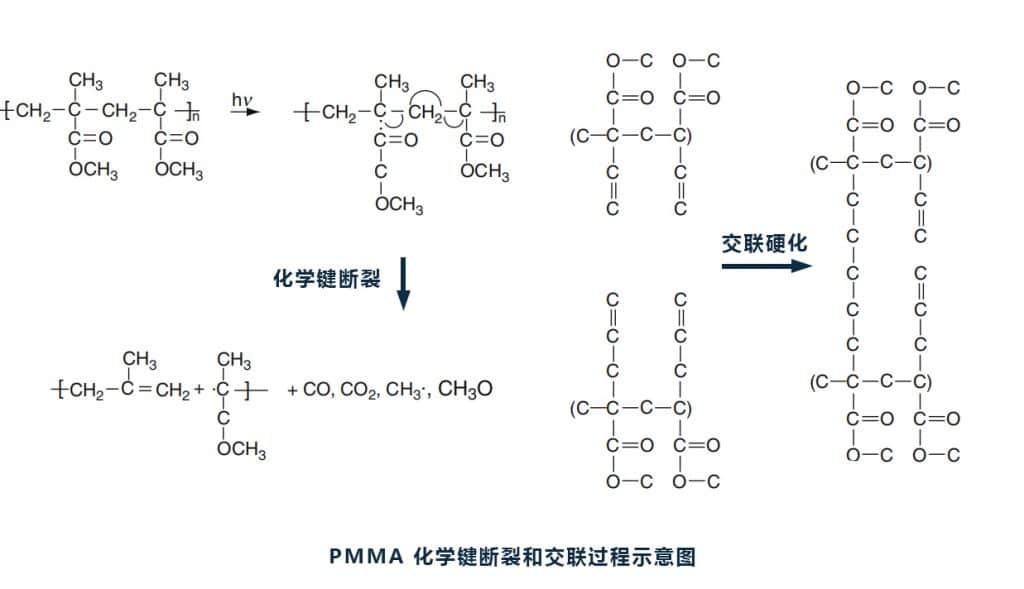
ポジ型フォトレジスト(オルトグルー):露光部のフォトレジストで化学結合の切断反応が支配的であり、現像液に溶けやすい。
ネガ型フォトレジスト(ネガ型接着剤):露光部のフォトレジストの架橋反応が支配的で、低分子が架橋・重合して大きな分子となり、現像液に溶解しにくい。

フォトレジストのキーパラメーター
UVフォトレジストと同様に、フォトレジストは通常、感度、コントラスト、解像度、エッチング耐性という4つのパラメータによって、プロセスへの適用を選択または評価される。
- 感性です。フォトレジストの感度が高いほど、必要な露光量(照射量)は少なくなります。 感度は、電子容量keV(または加速電圧kV)、基板材料、プロセス条件、使用する現像液などの影響を受けます
- コントラストをつける。高コントラストは、サイドウォールが急峻で、処理ヘッドルームが大きく、解像度が高く、アスペクト比の高い構造で、近接効果の影響を受けにくく、パターン密度が高くなります。低コントラストは3Dグレイスケールリソグラフィーにのみ使用可能です。
- 解像度です。は、得られる最小の特徴量の大きさ、または2つの構造物間の最小距離を定義する。
- エッチングに強い。エッチング工程が必要な場合は、化学的エッチング(ウェットエッチング)と物理的エッチング(ドライエッチング)において整合性が保たれるフォトレジストを選択します。
また、適切なフォトレジストの選択は、フォトレジストのプラスとマイナスの特性、プロセス耐性、接着性、熱流動性、膨張効果、保存寿命、その他のパラメータとの関連で考慮する必要があります。
一般的に使用されているフォトレジスト
フォトレジストは用途によって使い分けられるが、ここでは実験でよく使われるポジ型PMMA、ZEP-520A、AR-P 6200(SCAR62)、ネガ型HSQなどの濃縮電子ビームフォトレジストを紹介する。
PMMA(オルソグルー)
PMMA(ポリメタクリル酸メチル)は、アクリルやプレキシガラスとも呼ばれるポリマーで、現在最も普及している電子線フォトレジストです。5%~10%のPMMA粉末とクロロベンゼンまたはアニソール(毒性が低い、2~4%)を十分に混合してPMMAフォトレジストを作ることができます。フォトレジスト
- 安い、丈夫、扱いやすい
- 非常に高い解像度とコントラスト
- 低感度
- ドライエッチング耐性が低い(ピールリフトオフには良いが、ダイレクトエッチングによるパターン転写には適さない)
- 感度は相対分子量が小さくなるほど高くなり、PMMAの代表的な相対分子量は495kg/molと950kg/moである。
- コントラストと感度は、現像液中のMIBKの比率(MIBK:IPA)を変えることで調整でき、現像液中のMIBKの比率が高いほど感度が高くなり、コントラストはその逆になります。
Zep-520A(ポジティブラバー)
市販のフォトレジストとして最も普及しているZep-520Aは、α-クロロメタクリレートとα-メチルスチレンの共重合体からなるベンゼン環で変性したPMMAとして、日本の日本ゼオンが開発し、PMMAの代替品として使用されています。
- PMMAに匹敵する高解像度(10-30nmのグラフィック構造を実現可能)と高コントラストを実現した
- 高感度、PMMAより高感度(3~5倍)。
- 高いドライエッチング耐性 PMMAと比較して5倍以上のドライエッチング耐性があります。
- 高価で、賞味期限も1年。
- 超高分解能(10nm以下)の場合、PMMAの使用が望ましい場合があります。
- ZEP-520Aは、露光・現像・焼成後の固着除去が容易ではなく、通常はZDMACで粘着除去を行う。
AR-P 6200(CSAR62)(ポジティブラバー)
- 超高分解能(<10nm)
- 高感度、適切な現像剤の選択により、感度を調整できる。
- 高コントラスト比(15以上)
- 高アスペクト比から深アスペクト比まで(最大20:1)
- プロセス安定性が良く、ドライエッチングに対する耐性はPMMAの2倍です。
- 基材との密着性が良く、剥離やクラックが発生しにくい。
- ヤング率が低く、崩壊、付着、転倒しやすい。
- 融点が低いので、溶けにくさを演出することができる。
- グラフィカルなサーフェイスは収縮しやすい
HSQ(ネガティブグルー)
- 非常に高い分解能 (<10nm)
- 低感度で露光時間が長い。
- 溶解ではなく、化学反応(未露光のHSQと希釈NH4OHまたはNaOH現像液との反応によりH2を生成する)による現像で、現像後のプロセス安定性が良好です。
- 電子顕微鏡での観察性能が良く、金メッキを必要としない。
- シリコンのエッチングに適したマスク材です。
- 保存期間は6ヶ月程度と短いです。粉末状のHSQ(H-SiOx)であれば、より長い保存期間を確保することができる
- 過酷な保存条件、ゲルは空気に触れると酸化やゼリー硬化を起こしやすいので、低温(5℃)で密閉保存する必要があります。
- 非常にコントラストが高く、急峻で直線的なプロファイルと高いアスペクト比を持つ構造物を容易に作成することができます。
- 現像後のラインエッジの垂直性が良好なストレッチャブルフォトレジストです。
- 良好な接着性、強靭性、非破壊性を有する。
プロキシミティ効果
電子線露光の近接効果とは、2つの露光パターンが近接している場合、フォトレジストや基板中の電子が散乱して本来の入射方向からずれることにより、本来露光されないはずの隣接する領域が露光されたり、露光すべき領域が十分に露光されず露光パターンに歪みが生じることである。その結果、コントラストの低下や解像度の低下といった問題が発生する。
補正方法
- 用量補正最も一般的で効果的な方法であり、すべての露光画像に均一なエネルギーが人工的に照射されることを原理としている。また、線量補正は、自己整合的手法(物理補正)と幾何学的カット法に分けられます。セルフコンシステント技法(物理矯正): 比較的正確ですが、大規模な集積回路設計では計算量が多くなります。ジオメトリックカット法:計算される被ばく線量分布は粗くなるが、計算速度が非常に速い。
- グラフィックサイズ補正各グラフのサイズを小さくしたり大きくしたりすることで、局所的なエネルギーの高低の影響を補正し、単純なサイクルの繰り返しのグラフに適しています。
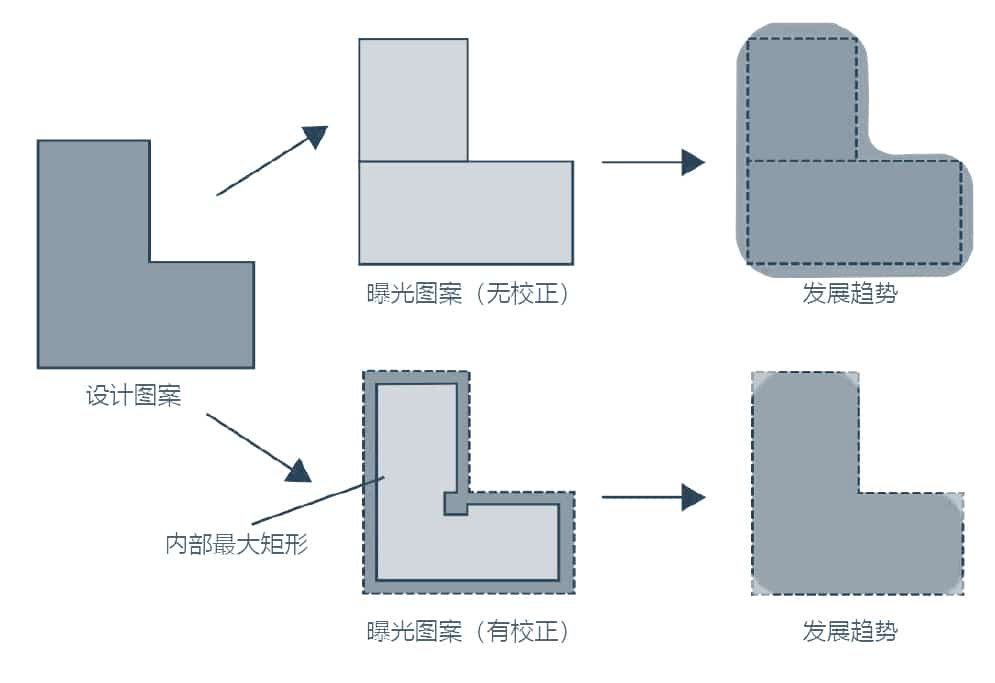
背景の露出補正ラスタースキャニング露光装置に適しており、2回目の露光によるエネルギーの重畳によって全箇所のエネルギー分布が均衡するため、エネルギー分布の計算が不要になるが、露光画像のコントラストが低下する場合がある。
近接効果を低減する最も単純で効果的な方法は、電子ビームエネルギーを大きくし、電子ビームフォトレジストの厚さを薄くすることです。しかし、高い電子ビームエネルギーによる基板の損傷や過熱の可能性を考慮する必要がある。

アプリケーション
高精度マスク:電子ビームリソグラフィーは、高解像度、直描型であることから、集積回路用の高精度マスク製造の分野で幅広く利用されています。
オプトエレクトロニクス:電子・光学チップの試作や小ロット生産、回折格子、バイナリー光学、マイクロ・ナノ光学(マイクロレンズアレイ、光導波路)、超表面レンズ産業における小ロット生産、特殊光学デバイスのカスタマイズなどです。
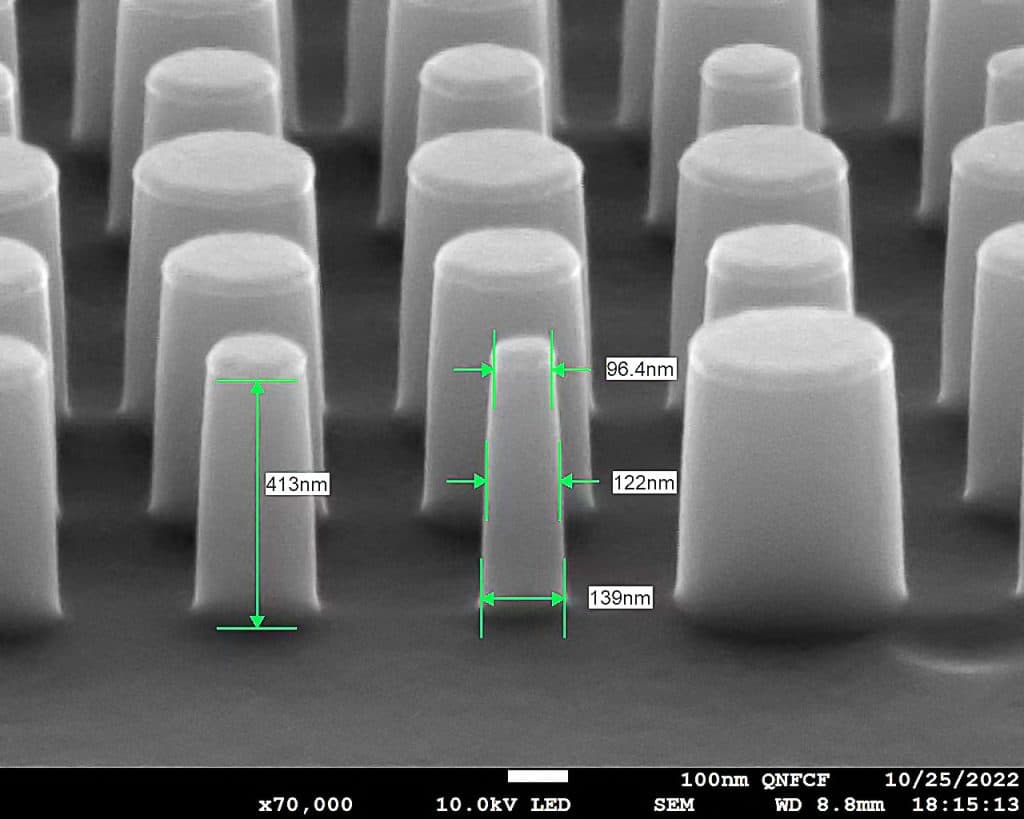
を提供しています。 電子ビームリソグラフィ / マイクロ・ナノ構造プロセス設計サービスお気軽にコメントをお寄せください。