Al0.78Sc0.22N薄膜中铁电体的厚度调整
介绍
随着科技的大力发展,低功耗非易失性存储器,包括磁阻随机存取存储器和铁电随机存取存储器(FRAM),已与用于物联网设备的低功耗微控制器集成。)与闪存相比,具有铁电Pb(ZrTi)O3 (PZT) 薄膜的 FRAM 远低于闪存。通常,铁电薄膜中的厚度缩放可以减小铁电电容器的尺寸,从而降低功耗。但是,众所周知,PZT 薄膜在将厚度减薄至小于 100nm 时会失去其铁电性。此外,带有贵金属电极的 PZT 薄膜与半导体工艺并不完全兼容。已经报道了几种铁电材料,因此远远取代传统的铁电材料。 2011年报道的铁电HfO2薄膜具有可以将其铁电性保持在3nm以下的优点。制造过程可以在低温下通过完全兼容的半导体工艺完成。此外,2019 年报道了铁电 Al1−xScxN 薄膜,其剩余极化率 (Pr) 超过 100 μC cm−2.26,27) A高 Pr 也很有吸引力,因为可以进一步减少铁电电容器的电极以获得更高的体积密度,并且在写入和读取操作期间电流感应可以容易地抵抗噪声。
Al1−xScxN 薄膜的问题之一是矫顽场 (EC) 相对较高,这取决于 Al1−xScxN 薄膜中 Sc 原子的组成 (x) ,并且是可控的。在术语方面的优势Al1-xScxN的纤锌矿型结构在 0 < x < 0.46范围内是 Al-Sc-N 体系中的稳定相极性(对于氮化物情况、金属面或 N 面),我们可以预期在薄膜区域也有自极化 c 轴取向的 Al1−xScxN 薄膜沉积。
我们已经报道了一些与厚度相关的铁电性能低至 20 nm。我们将表征 Al0.78Sc0.22N 薄膜的厚度效应的工作扩展到薄膜中的晶体取向程度和铁电性能。用过氧化硫混合物 (SPM,H2SO4/H2O2= 3:1) 溶液对掺杂密度为 3 × 1018 cm-3 的 n+Si 衬底进行化学清洗,然后用稀释的 HF(1%) 浸渍。在 0.22Pa 的压力下,在 Ar 和 N2 气体流量分别为 4 和 6 sccm 的 Ti 靶材上,以 300 W 的射频功率在衬底上溅射沉积 TiN 底部电极。然后,Al0.78Sc0.22N 薄膜通过直流溅射在 300W 下从 Al0.57Sc0.43 靶材上沉积,Ar 和 N2 气流分别为 5 和 10sccm,压力为 0.7Pa。在此条件下沉积的 Al0.78Sc0.22N 薄膜的成分由 X 射线光电子能谱测定。我们改变了Al0.78Sc0.22N 薄膜的沉积时间,以形成厚度为10-47nm 的薄膜。另一个 TiN 层原位沉积在 Al0.78Sc0.22N 薄膜上。所有的沉积过程温度保持恒定在 400 °C。使用过氧化铵混合物 (APM,NH4OH: H2O2:H2O = 1:5:5) 通过湿法蚀刻对顶部 TiN 层进行光刻图案化以形成顶部电极。最后,通过热蒸发形成铝背接触。我们已经证实,电容器在施加的电场中具有几乎相同的漏电流,表明薄膜内部和界面附近的缺陷密度大小是相同的。评估了薄膜中晶粒的结晶和取向通过平面外和摇摆曲线配置下的 X 射线衍射 (XRD)。 X 射线源是发散角为 0.04° 的 CuKa。使用 Agilent E4980A LCR 计在 100 kHz 下以 50 mV 的小信号幅度获得电容 – 电压 (CV) 特性。极化 – 电压 (PV)使用 TOYO 公司的 FCE10 系列设置在 10 kHz 下测量电容器的特性。
应用情况
本文中主要阐述了的是已经检查了溅射沉积的无极化Al0.78Sc0.22N 薄膜的铁电性能的厚度缩放。 通过 X 射线摇摆曲线测量,用薄至 10 nm的薄膜确认了 c 轴取向的薄膜。 从电容测量中观察到铁电型滞后和无极化行为,即使厚度为 20 nm。 当厚度小于 35 nm 时,剩余极化 (Pr) 显示出逐渐退化。 开关 (SW) 循环测试揭示了薄膜的唤醒效应,特别是对于超过 35 nm的厚薄膜。
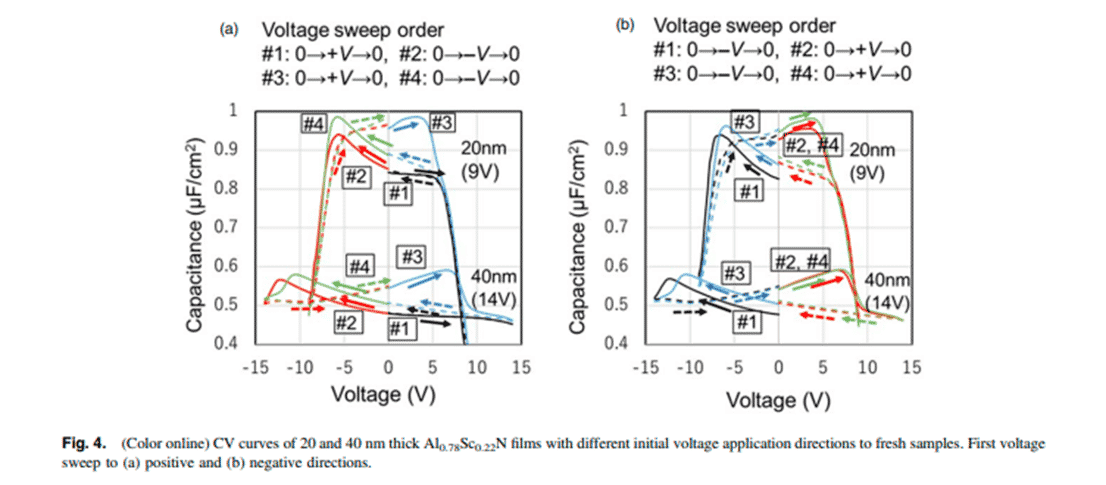
我们对 20 和 40 nm 厚的 Al0.78Sc0.22N 薄膜进行了极性相关的 CV 测量,如图 4 所示。 最初应用于样品,电容在上下扫描之间几乎没有差异[图4(a)]。 随后,通过向顶部电极施加负电压,观察到电容逐渐增加并伴随着在一定电压下的突然下降。 以下向正方向施加的电压显示出铁电开关 (SW) 行为。 另一方面,当对新鲜样品施加的初始电压设置为负方向时,如图4(b)所示,我们看到电容突然下降,表明薄膜被切换。 从这些测量中,我们可以得出结论,Al0.78Sc0.22N 薄膜已经在从表面到基板的方向上自极化。
来源
作者:Sung-Lin Tsai,Takuya Hoshii1,HitoshiWakabayashi1,Kazuo Tsutsui,Tien-Kan Chung ,Edward Yi Chang,and KuniyukiKakushima
机构:School of Engineering, Tokyo Institute ofTechnology, 4259 S2-20, Nagatsuta, Midori-ku, Yokohama 226-8502, Japan 2International College of Semiconductor Technology, National Chiao TungUniversity, 1001 University Road, Hsinchu 30010, Taiwan ROC 3 Institute ofInnovative Research, Tokyo Institute of Technology, 4259 S2-20, Nagatsuta,Midori-ku, Yokohama 226-8502, Japan 4 Department of Mechanical Engineering,National Chiao Tung University, 1001 University Road, Hsinchu 30010, Taiwan ROC
发布时间:Received October 16, 2020; revised March 7, 2021;accepted March 16, 2021; published online April 1, 2021
期刊:Japanese Journal of Applied Physics 60, SBBA05(2021)
文章来源网站:On the thickness scaling of ferroelectricity inAl0.78Sc0.22N films(https://iopscience.iop.org/article/10.35848/1347-4065/abef15/pdf)
