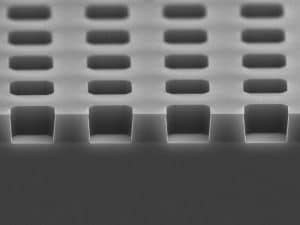
微纳加工 | 薄膜沉积工艺介绍
目录
什么是薄膜沉积(镀膜)?
薄膜沉积(镀膜)是在基底材料上形成和沉积薄膜涂层的过程,在基片上沉积各种材料的薄膜是微纳加工的重要手段之一,薄膜具有许多不同的特性,可用来改变或改善基材性能的某些要素。例如,透明,耐用且耐刮擦;增加或减少电导率或信号传输等。薄膜沉积厚度范围从纳米级到微米级。
薄膜沉积是许多光电、固态和医疗设备及产品生产中的重要制造步骤,包括消费电子产品、半导体激光器、光纤激光器、LED 显示器、滤光片、化合物半导体、精密光学、显微镜和微量分析样品载玻片和医疗植入物。
薄膜沉积工艺种类及优劣对比
微纳加工中最常用的薄膜沉积工艺是物理气相沉积(PVD)与化学气相沉积(CVD)。
物理气相沉积(PVD)是指在真空状态下,加热源材料,使原子或分子从源材料表面逸出从而在衬底上生长薄膜的方法。物理气相沉积的主要方法有,真空电子束或电阻蒸镀、溅射镀膜、电弧等离子体镀、离子镀膜,及分子束外延等。AEMD的电子束蒸发系统和溅射系统都属于物理气相沉积。
物理气相沉积(PVD) 可以分为热蒸发沉积和等离子体溅射沉积两大类,热蒸发沉积:电阻蒸发沉积、电子束蒸发沉积;等离子体溅射沉积:直流溅射、射频溅射、磁控溅射、离子化PVD。
化学气相沉积(CVD)是使气态物质在固体的表面上发生化学反应并在该表面上沉积,形成稳定的固态薄膜的过程。主要分为四个重要的阶段:1、反应气体向基体表面扩散;2、反应气体吸附于基体表面;3、在基体表面上产生的气相副产物脱离表面;4、留下的反应物形成覆层。采用等离子和激光辅助等技术可以显著地促进化学反应,使沉积可在较低的温度下进行。
化学气相沉积(CVD)包括低压型(LPCVD)、常压型(APCVD)、原子层沉积(ALD)、等离子体增强型(PECVD)和金属有机化合物型(MOCVD)等
原子层沉积(ALD)是化学气相沉积(CVD)法的一种,是一种可以将物质以单原子膜形式一层一层的镀在基底表面的方法。原子层沉积与普通的化学沉积有相似之处。但在原子层沉积过程中,新一层原子膜的化学反应是直接与之前一层相关联的,使这种方式每次反应只沉积一层原子。
各种薄膜沉积方式的优劣对比
| 工艺 | 原子层沉积 (ALD) | 物理气相沉积 (PVD) | 化学气相沉积 (CVD) | 低压化学气相沉积 (LPCVD炉管) |
|---|---|---|---|---|
| 沉积原理 | 化学表面饱和 反应-沉积 | 蒸发-凝固 | 气相反应-沉积 | 低压化学气相沉积 (炉管式) |
| 沉积过程 | 层状生长 | 形核长大 | 形核长大 | 形核长大 |
| 台阶覆盖率 | 优秀 | 一般 | 好 | 好 |
| 沉积速率 | 慢 | 快 | 快 | 较慢 |
| 沉积温度 | 低(<500℃) | 低 | 高 | 更高 |
| 均匀性 | 优秀 0.07 – 0.1nm | 一般 5nm左右 | 较好 0.5 – 2nm | 更好 |
| 厚度控制 | 反应循环次数 | 沉积时间 | 沉积时间 气相分压 | 沉积时间 气体比 |
| 成分 | 均匀杂质少 | 无杂质 | 易含杂质 | 无杂质 |
薄膜种类及应用场景
| 薄膜种类 | 分类 | 薄膜沉积材料 | 应用 |
| 半导体 | 多晶硅 | SiH4(硅烷) | MOS的栅极、高值电阻等 |
| 单晶硅 | SiH₂Cl₂(二氯硅烷; DCS) | 功率器件的单晶外延层等 | |
| SiHCl3(三氯硅烷;TCS) | |||
| SiCl4 ( 氯化硅; Siltet) | |||
| 非晶硅 | SiH4(硅烷) | α-Si太阳能电池、源极/漏极沟道区等 | |
| 介电质 | Si02(二氧化硅) | SiH4,O2 SiH4,N20 Si(OC2H5)4(四乙氧基硅烷)、O2/O3 | 应用最广泛的介电质薄膜,STI、栅氧化层、侧墙、PMD、IMD、阻挡层、硬掩膜等 |
| Si3N4/SiN(氮化硅) | SiH4、N2O、N2、NH3 C8H22N2Si [ 双(叔丁基氨基)硅烷 ] | 刻蚀停止层 、硬掩膜 、钝化层等 | |
| SiON(氮氧化硅) | SiH4、N2O、N2、NH3 | 抗反射层、栅氧化层、硬掩膜等 | |
| PSG/BPSG ( 磷硅 / 硼磷硅玻璃 ) | 硅烷 、 硼烷 、 磷烷等 | PMD、钝化层等 | |
| Low- K(低介电)材料 | 聚酰亚胺 ( PI ) 等 | 在PMD中替代 SiO2 | |
| High-K (高介电)材料 | Hf、O2 、 SiO2 等 | 在栅介质层中替代 SiO2 | |
| 金属 金属化合物 | W ( 钨 ) | WF6 ( 六氟化钨 )、SiH4 、H2 | 电学薄膜、光学薄膜、硬质膜、耐蚀膜、接触孔、通孔、栅极等 |
| WSi2/TiSi2 /CoSix/NiSi | WF6 、 硅烷等 | 源/漏/栅极上的硅化物层 | |
| TiN | Ti[N(CH3)2]4 [ 四(二甲氨基)钛 ] | 阻挡层、金属栅等 | |
| Ti | TiCl4 (氯化钛) | ||
| Ta/TaN | |||
| Au/Al/Cu | 金属层、金属栅等 |
我们提供快速 薄膜沉积 / 微纳米结构加工设计服务, 欢迎留言咨询。


