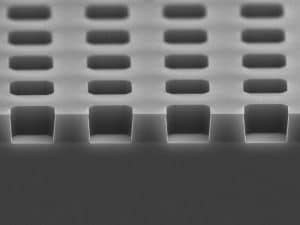
Микро- и нанообработка | Введение в процессы осаждения тонких пленок
Что такое тонкопленочное осаждение (покрытие)?
Сравнение типов процессов осаждения тонких пленок, их преимущества и недостатки
Физическое осаждение из паровой фазы (PVD) - это метод выращивания тонких пленок на подложке путем нагревания исходного материала в вакууме, так что атомы или молекулы выходят с поверхности исходного материала.Основными методами физического осаждения из паровой фазы являются вакуумное электронно-лучевое или резистивное осаждение из паровой фазы, напыление, дуговое плазменное покрытие, ионное покрытие, молекулярно-лучевая эпитаксия и т.д. Система электронно-лучевого испарения и система напыления AEMD относятся к физическому осаждению из паровой фазы.
ВещиФизическое осаждение из паровой фазы (PVD) можно разделить на две основные категории: осаждение термическим испарением и осаждение плазменным напылением.Осаждение термическим испарением:Осаждение испарением сопротивления, ,Осаждение испарением электронным лучом(a) Ниже перечислены некоторые из наиболее распространенных и наиболее популярных продуктов в мире;Осаждение плазменным напылением:: СледующееНапыление постоянным током, радиочастотное напыление, магнетронное напыление, ионизированное PVD.
Химическое осаждение из паровой фазы (CVD) - это процесс, в котором газообразное вещество вступает в химическую реакцию на поверхности твердого тела и осаждается на этой поверхности, образуя устойчивую твердую пленку.Существует четыре основных важных этапа: 1) диффузия реакционного газа к поверхности подложки; 2) адсорбция реакционного газа на поверхности подложки; 3) отщепление побочных продуктов газовой фазы, образующихся на поверхности подложки, от поверхности; и 4) формирование облицовочного слоя из оставшихся реактивов. Использование таких методов, как плазменное и лазерное воздействие, может значительно облегчить химические реакции, позволяя проводить осаждение при более низких температурах.
Химическое осаждение из паровой фазы (CVD)Включая осаждение под низким давлением (LPCVD), атмосферным давлением (APCVD), осаждение атомных слоев (ALD), плазменное усиление (PECVD) и металлоорганические соединения (MOCVD).
Атомно-слоевое осаждение (ALD)Это разновидность химического осаждения из паровой фазы (CVD) - метода, позволяющего наносить вещества на поверхность подложки в виде одноатомной пленки слой за слоем. Осаждение атомного слоя имеет сходство с обычным химическим осаждением. Однако при атомно-слоевом осаждении химическая реакция нового слоя атомов непосредственно связана с предыдущим слоем, что позволяет таким образом осаждать только один слой атомов за реакцию.
Сравнение преимуществ и недостатков различных методов осаждения пленки
| Ремесло | Осаждение атомного слоя (ALD) | Физическое осаждение из паровой фазы (PVD) | Химическое осаждение из паровой фазы (CVD) | Химическое осаждение из паровой фазы при низком давлении (трубки печи LPCVD) |
|---|---|---|---|---|
| Принцип осаждения | Химическое насыщение поверхности Реакция-осаждение | Испарение-консолидация | Газофазная реакция - осаждение | Химическое осаждение из паровой фазы при низком давлении (Плита и труба) |
| Процесс осаждения | Ламинарный рост | Нуклеационный рост | Нуклеационный рост | Нуклеационный рост |
| Покрытие террасы | Отличный | Общий | Хорошо | Хорошо |
| Скорость осаждения | медленно | Быстро | Быстро | Медленнее |
| Температура осаждения | Низкая (<500°C) | Низкий | Высокий | Выше |
| Однородность | Отличный 0,07 - 0,1 нм | Общий Около 5 нм | Лучше 0,5 - 2 нм | Лучше |
| Контроль толщины | Количество циклов реакции | Время осаждения | Время осаждения Парциальное давление паровой фазы | Время осаждения Соотношение газов |
| Ингредиенты | Однородность с небольшим количеством примесей | Неподкупный | Легко удерживает загрязнения | Неподкупный |
Типы пленок и сценарии применения
| Типы фильмов | Классификация | Материалы для осаждения тонких пленок | Приложения |
| Полупроводники | Поликремний | SiH4 (силан) | Гейты, резисторы высокого номинала и т.д. для MOS |
| Монокристаллический кремний | SiH₂Cl₂ (дихлорсилан; DCS) | Монокристаллические эпитаксиальные слои для энергетических устройств и т.д. | |
| SiHCl3 (трихлорсилан; TCS) | |||
| SiCl4 (хлорид кремния; Силтет) | |||
| Аморфный кремний | SiH4 (силан) | Солнечные элементы Alpha-Si, площадь траншеи истока/стока и т.д. | |
| Качество диэлектрика | Si02 (диоксид кремния) | SiH4, O2 SiH4, N20 Si(OC2H5)4 (тетраэтоксисилан), O2/O3 | Наиболее широко используются диэлектрические пленки, STI, оксид затвора, боковые стенки, PMD, IMD, резист, жесткая маска и т.д. |
| Si3N4/SiN (нитрид кремния) | SiH4, N2O, N2, NH3 C8H22N2Si [ Бис(трет-бутиламино)силан]. | Протравочный слой, твердая маска, пассивирующий слой и т.д. | |
| SiON (нитрид кремния) | SiH4, N2O, N2, NH3 | Антибликовые слои, оксидные решетки, жесткие маски и т.д. | |
| ПСЖ/БПСГ (Фосфоросиликатное / боросиликатное стекло) | Силаны, бораны, фосфораны и т.д. | PMD, пассивирующий слой и т.д. | |
| Материалы с низким К (низким диэлектриком) | Полиимид (PI) и т.д. | Замена SiO2 в PMD | |
| Материалы с высоким К (высоким диэлектриком) | Hf, O2, SiO2 и т.д. | Замена SiO2 в слое решетчатого носителя | |
| Металл Соединения металлов | W (вольфрам) | WF6 (гексафторид вольфрама), SiH4, H2 | Электрические пленки, оптические пленки, жесткие пленки, коррозионностойкие пленки, контактные отверстия, сквозные отверстия, затворы и т.д. |
| WSi2/TiSi2 /CoSix/NiSi | WF6, силан и т.д. | Силицидный слой на истоке/стоке/затворе | |
| TiN | Ti[N(CH3)2]4 [ тетракис(диметиламино)титан]. | Барьерные слои, металлические решетки и т.д. | |
| Ti | TiCl4 (хлорид титана) | ||
| Ta/TaN | |||
| Au/Al/Cu | Металлические слои, металлические решетки и т.д. |
Расширенное чтение:
- Микро- и нанообработка | Обзор
- Микро- и нанообработка | Фотолитография - Наноимпринтная литография
- Микро- и нанообработка | литография - фокус на ионно-лучевых ФИБах
- Микро- и нанообработка | Литография - Электронно-лучевая литография
- Микро- и нанообработка | Фотолитография - Оптическая литография
- Микро- и нанообработка | травление
- Микро- и нанообработка | подготовка тонких пленок - эпитаксия
- Микро- и нанообработка | Подготовка тонких пленок - PVD
- Микро- и нанообработка | Подготовка тонких пленок - CVD
Мы предлагаем быстрый Осаждение тонких пленок / Услуги по проектированию обработки микро- и наноструктур, Не стесняйтесь оставить сообщение с вашим запросом.


