
Introducción a la litografía por haz de electrones (EBL)
¿Qué es la litografía por haz de electrones?
La litografía por haz de electrones (e-beam lithography; EBL) es un tipo de litografía sin máscara que utiliza electrones focalizados de longitudes de onda extremadamente cortas para actuar directamente sobre la superficie de un fotorresistente sensible a los electrones (resist) y formar una micro y nanoestructura que coincida con el patrón diseñado. Los sistemas EBL tienen las ventajas de la resolución ultraalta (transferencia gráfica con un tamaño límite de <10nm) y el patronaje flexible (escritura directa sin máscara), pero debido a la baja eficacia de la exposición y al complejo control, la EBL se utiliza más comúnmente para máscaras litográficas, prototipos de principios avanzados e investigación y desarrollo científicos a nanoescala.
Historia del desarrollo
- Primer uso de la contaminación por carbono inducida por electrones para formar una máscara de grabado con el fin de producir una estructura gráfica bidimensional de alta resolución por investigadores del MIT en 1958.
- Desde 1965 se utilizan haces de electrones para producir estructuras de 100 nm.
- 1968 El PMMA se utiliza como fotorresistente de haz de electrones
- 1970 Dispositivo de ondas sonoras superficiales de 0,15 um fabricado con PMMA
- 1972: Líneas metálicas de aluminio de 60x60nm con sección transversal sobre superficie de silicio mediante litografía por haz de electrones
En la década de 1980 se creía que la exposición óptica había llegado a su fin y que la litografía por haz de electrones era la alternativa más prometedora. Sin embargo, más de 30 años después, la litografía por haz de electrones sigue sin sustituir a la exposición óptica. En el desarrollo de las dos tecnologías litográficas ha ido surgiendo gradualmente un patrón complementario y se cree que este patrón se mantendrá durante mucho tiempo.
Fundamentos teóricos
La resolución de la exposición óptica está limitada por la longitud de onda de la luz. Para mejorar la resolución de la exposición óptica, la elección de la longitud de onda de la luz ha experimentado un proceso de desarrollo desde la línea G hasta la línea I, el ultravioleta profundo y el ultravioleta extremo con acortamiento continuo.
Los haces de electrones son esencialmente partículas cargadas y, según la teoría de la dualidad onda-partícula, tienen una longitud de onda de

Sistemas de exposición por haz de electrones
- La fuente de electrones calientes es un cátodo calentado a una temperatura lo suficientemente alta como para que los electrones del material del cátodo puedan ganar suficiente energía cinética para permitir que los electrones atraviesen la barrera de potencial de la función de trabajo del metal del cañón de electrones y sean emitidos para formar un haz de electrones.
- La fuente de emisión de campo se forma reforzando el campo eléctrico para que los electrones atraviesen la barrera de potencial y formen la fuente de electrones. El enfoque y la desviación del haz de electrones de la fuente se realiza en la columna del haz de electrones, que consta de una serie de lentes de electrones, diafragmas, deflectores y otros dispositivos. Los electrones son moldeados por el diafragma, convergidos en un punto del haz por la lente de electrones y luego expuestos en el banco por el sistema de desviación.

Indicadores importantes para los sistemas de exposición a haces de electrones
- Diámetro mínimo del haz:Esto afecta directamente al tamaño mínimo de la imagen expuesta. Se pueden conseguir diámetros de punto más pequeños ajustando las siguientes medidas: (i) ajustando la tensión de aceleración lo más alta posible (ii) utilizando una apertura de diafragma más pequeña (iii) utilizando una distancia de trabajo más pequeña (iv) ajustando un campo de exploración más pequeño (v) ajustando un paso de exposición más pequeño.
- Tensión de aceleración:Generalmente, cuanto mayor es la tensión de aceleración, de 10 a 100 kv, mayor es la resolución y menor el efecto de proximidad de la exposición, lo que permite exponer resistencias más gruesas.
- Flujo de haces de electrones:Cuanto mayor sea la corriente del haz, mayor será la velocidad de exposición; la velocidad máxima de exposición está limitada por la frecuencia de barrido y el punto del haz será mayor para corrientes del haz mayores.
- Velocidad de escaneado:Cuanto mayor sea la velocidad de exploración, mayor será la velocidad de exposición, expresada en frecuencia (por ejemplo, 50 MHz)
- Tamaño del campo de exploración:Con un campo de escaneado grande, la mayor parte de la imagen expuesta puede exponerse dentro del campo de escaneado, lo que evita errores causados por la unión del campo de escaneado.
- También la precisión del movimiento de la mesa, la precisión del registro, la precisión del empalme de campo, etc.
Clasificación de los métodos de exposición al haz de electrones
Dividido por método de trabajo
Exposición de proyección (requiere máscara) y exposición directa (no requiere máscara)
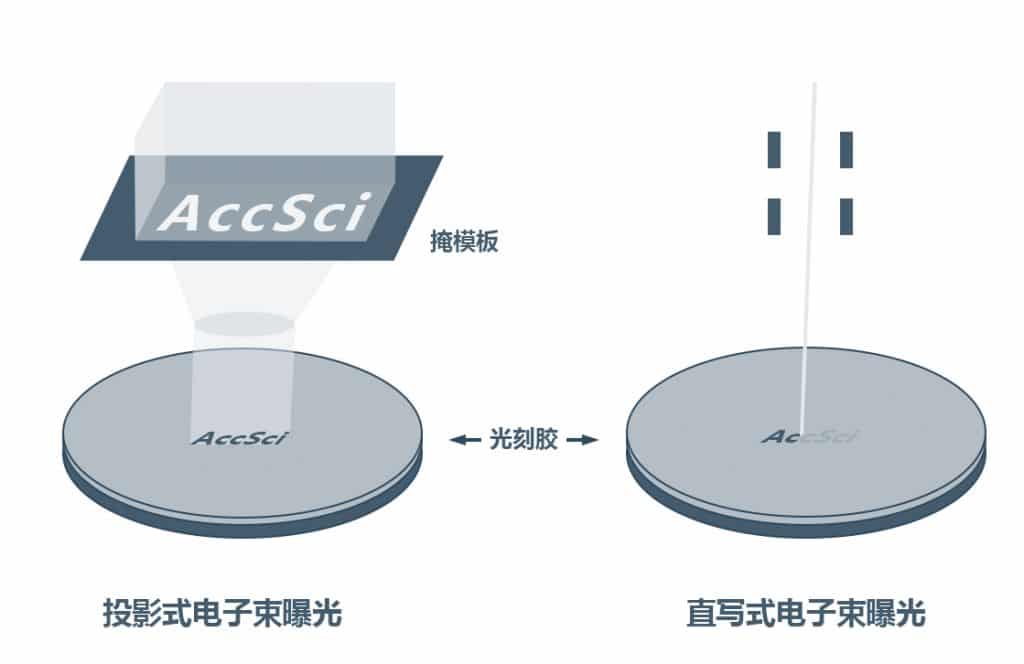
Dividido por método de escaneado
Hay un escaneado raster y un escaneado vectorial
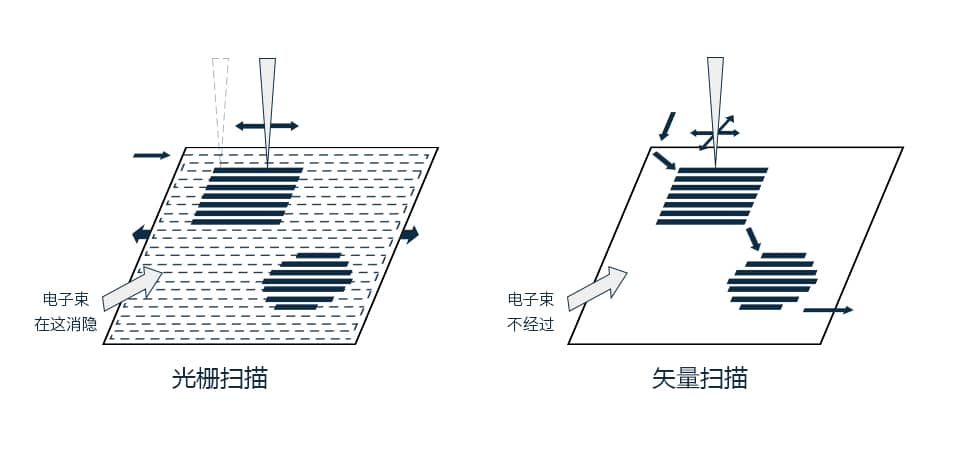
- Escaneado de tramaUtilizando un haz circular gaussiano, el haz de electrones se explora continuamente punto por punto en todo el campo de exploración, y la imagen se expone controlando la apertura y el cierre del obturador (puerta del haz).La ventaja del escaneado de trama es que es fácil de controlar y no requiere el control del sistema de desviación. La desventaja es la baja eficiencia de producción. Debido al pequeño campo de exploración, la exposición debe completarse junto con el movimiento de la mesa de la pieza de trabajo.
- Exploración vectorialLas ventajas de la exploración vectorial son que la exposición es eficiente, sólo se explora el área gráfica para la exposición, lo que reduce el tiempo empleado por el objetivo en el área no gráfica, y se puede utilizar un haz rectangular variable. La desventaja es que el sistema de control es complejo, ya que el deflector debe controlarse para la exploración vectorial, a diferencia de la exploración de trama, en la que se utiliza una deflexión fija.
Por la forma del haz de electrones
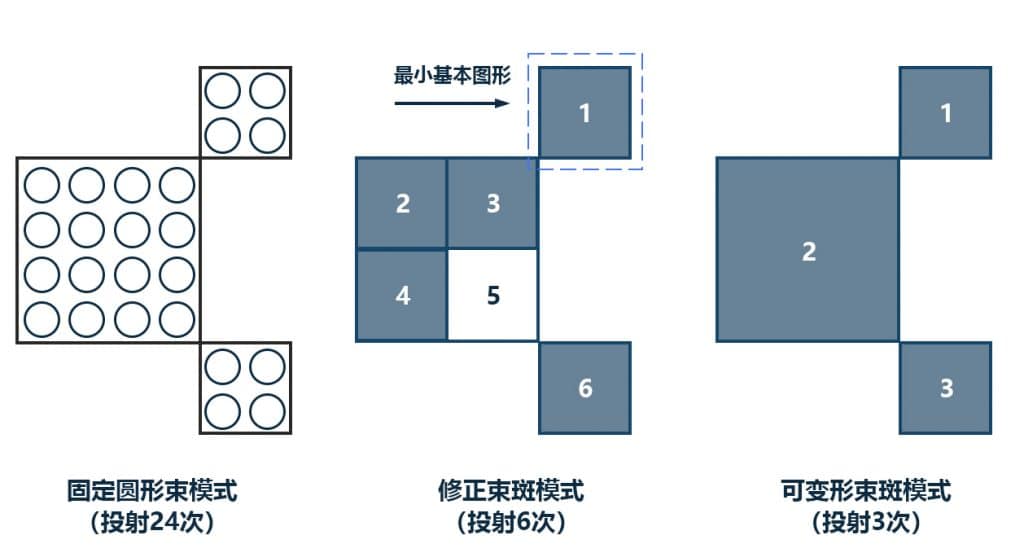
En el modo de exploración vectorial, el tiempo de exposición del patrón está relacionado con el número de proyecciones del punto del haz.En el patrón de punto de haz gaussiano fijo (haz circular), necesitamos realizar 24 proyecciones.
Para acelerar la velocidad de exposición, el patrón puede descomponerse en combinaciones del patrón básico más pequeño, utilizando el patrón básico más pequeño como forma del punto del haz de electrones. Sólo se requieren 6 proyecciones en este modo de punto de haz modificado.
En la práctica, sin embargo, el patrón no es constante y la forma básica del haz debe reajustarse con frecuencia, por lo que se requiere un método de proyección más flexible. Un patrón de haz variable puede utilizarse en situaciones en las que el patrón es diverso. Como se muestra en la figura siguiente, en el modo de patrón de haz variable, el punto del haz de electrones puede ajustarse al patrón específico, cambiando la forma básica del punto del haz y reduciendo el número de proyecciones a tres.
Introducción a las fotorresistencias por haz de electrones
Fotoresistente (Fotoresistente; también conocido como fotorresistente ) es un material de película fina resistente al grabado cuya solubilidad se modifica por irradiación o radiación de fuentes luminosas como la luz ultravioleta, los láseres excimer, los haces de electrones, los haces de iones y los rayos X.
Las fotorresistencias de haz de electrones suelen dividirse en fotorresistencias positivas y negativaspueden dividirse en función de quién domine la reacción de reticulación o la ruptura del enlace químico tras la irradiación fotorresistente.Las propiedades positivas y negativas de las fotorresistencias no son absolutasLas propiedades de, por ejemplo, las colas positivas de haz de electrones PMMA pueden utilizarse como colas negativas cuando las colas de la zona expuesta se carbonizan a una dosis de exposición 10 veces superior a la normal, lo que produce residuos durante el proceso de revelado.
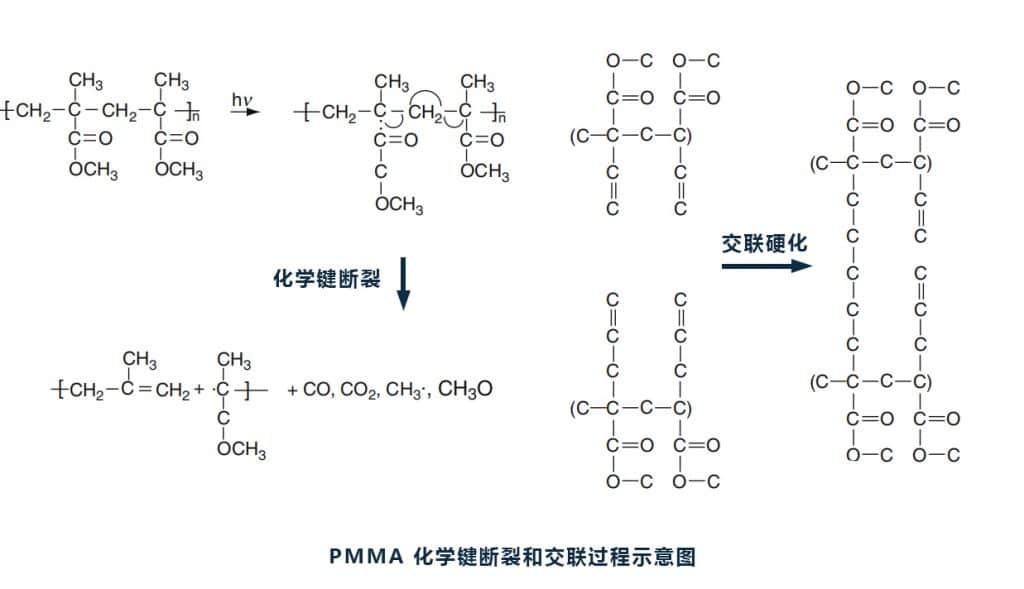
Fotorresistencia positiva (ortho-glue): en la fotorresistencia domina la reacción química de ruptura de enlaces en la zona expuesta y es fácilmente soluble en el revelador.
Fotoresistencia negativa (adhesivo negativo): la reacción de reticulación de la fotoresistencia en la zona de exposición es dominante y consiste en pequeñas moléculas reticuladas y polimerizadas en grandes moléculas, difíciles de disolver en la solución de revelado.

Parámetros clave de las fotorresistencias
Al igual que las fotorresistencias UV, una fotorresistencia suele seleccionarse o evaluarse para su aplicación en un proceso en función de cuatro parámetros: sensibilidad, contraste, resolución y resistencia al grabado.
- Sensibilidad:Cuanto mayor sea la sensibilidad del material fotorresistente, menor será la dosis de exposición (irradiación) necesaria. En la sensibilidad influyen la capacidad de electrones keV (o la tensión de aceleración kV), el material del sustrato, las condiciones del proceso, el revelador utilizado y otros factores
- Contraste:El alto contraste proporciona paredes laterales más inclinadas, mayor margen de procesamiento, mejor resolución, estructura de mayor relación de aspecto, lo que la hace menos sensible a los efectos de proximidad, y mayor densidad de patrones. El bajo contraste sólo está disponible para la litografía 3D en escala de grises.
- Resolución:define el tamaño de la característica más pequeña que se puede obtener o la distancia mínima entre dos estructuras.
- Resistente al grabado:Si se requiere un proceso de grabado posterior, elija una fotorresistencia que mantenga su integridad durante el grabado químico (húmedo) y físico (seco).
La selección de una fotorresistencia adecuada también debe considerarse en relación con las características positivas y negativas de la fotorresistencia, la tolerancia del proceso, la adhesión, la fluidez térmica, los efectos de expansión, la duración de almacenamiento y otros parámetros.
Fotorresistencias de uso común
En esta sección se presentan las fotorresistencias de haz de electrones concentrado más utilizadas en experimentos, como PMMA positivo, ZEP-520A, AR-P 6200 (SCAR62) y HSQ negativo.
PMMA (pegamento ortopédico)
El PMMA (polimetacrilato de metilo), un polímero, también conocido como acrílico o plexiglás, es actualmente el fotorresistente de haz de electrones más popular. 5%~10% de polvo de PMMA y clorobenceno o anisol (menos tóxico, 2-4%) pueden mezclarse completamente para fabricar el fotorresistente de PMMA. fotorresistente.
- Barato, duradero y fácil de manejar
- Resolución y contraste muy elevados
- Baja sensibilidad
- Escasa resistencia al grabado en seco (buena para el despegado, no adecuada para la transferencia directa de patrones de grabado).
- La sensibilidad aumenta a medida que disminuye la masa molecular relativa, siendo las masas moleculares relativas típicas para el PMMA de 495 kg/mol y 950 kg/mo
- El contraste y la sensibilidad pueden modularse cambiando la proporción de MIBK en la mezcla de revelador (MIBK:IPA), aumentando la sensibilidad con la proporción de MIBK en el revelador y lo contrario para el contraste.
Zep-520A (goma positiva)
Zep-520A, el fotorresistente comercial más popular, fue desarrollado por Nippon Zeon en Japón como un PMMA modificado con un anillo de benceno, consistente en un copolímero de α-clorometacrilato y α-metilestireno, utilizado como sustituto del PMMA.
- Alta resolución y alto contraste con una alta resolución comparable a la del PMMA (10-30nm de estructura gráfica alcanzable) y alto contraste
- Alta sensibilidad, con la mayor sensibilidad del PMMA (de 3 a 5 veces)
- Alta resistencia al grabado en seco, más de 5 veces más resistente al grabado en seco en comparación con el PMMA.
- Caro y con una vida útil de un año.
- Para tasas de clasificación ultra altas (sub-10nm), puede ser preferible el uso de PMMA.
- ZEP-520A no es fácil de quitar después de la exposición, el desarrollo y la cocción de la película firme, por lo general ZDMAC se utiliza para eliminar el adhesivo.
AR-P 6200 (CSAR62) (caucho positivo)
- Resolución ultra alta (<10 nm)
- Alta sensibilidad, la sensibilidad puede ajustarse seleccionando el revelador adecuado.
- Relación de contraste elevada (>15)
- Relación de aspecto de alto a profundo (hasta 20:1)
- Buena estabilidad de proceso y resistencia al grabado en seco, que duplica la del PMMA;
- Buena adherencia al sustrato, menos propenso a despegarse y agrietarse;
- Módulo de Young bajo, propenso al colapso, la adherencia y el vuelco;
- Puntos de fusión más bajos, que pueden producir resistencia a la fusión;
- Las superficies gráficas tienden a encogerse
HSQ (pegamento negativo)
- Resolución muy alta (<10 nm)
- Baja sensibilidad y largos tiempos de exposición;
- Desarrollo por reacción química (reacción de HSQ no expuesta con revelador NH4OH o NaOH diluido para formar H2), no por disolución, con buena estabilidad del proceso postdesarrollo;
- Buen rendimiento de visualización en microscopía electrónica, sin chapado en oro;
- Un buen material de máscara para grabar silicio;
- La vida útil es corta, con un periodo de almacenamiento de sólo 6 meses. HSQ (H-SiOx) en polvo tendrá una vida útil más larga.
- Condiciones duras de almacenamiento, el gel es susceptible a la oxidación y al curado gelatinoso cuando se expone al aire y necesita mantenerse sellado a bajas temperaturas (5°C);
- Estructuras de muy alto contraste, fáciles de preparar, con perfiles empinados y rectos y elevadas relaciones de aspecto;
- Una fotorresistencia estirable con buena verticalidad de los bordes de línea tras el revelado;
- Buena adherencia, tenacidad e irrompibilidad;
Efecto de proximidad
El efecto de proximidad de la exposición con haz de electrones se produce cuando dos patrones expuestos están próximos entre sí, debido a la dispersión de electrones en el fotorresistente y el sustrato para hacer que los electrones se desvíen de la dirección original de incidencia, lo que provoca la exposición de zonas adyacentes que no deberían exponerse, mientras que algunas zonas que deberían exponerse no reciben suficiente exposición, lo que provoca la distorsión del patrón expuesto. Esto provoca problemas como la reducción del contraste y de la resolución.
Método de corrección
- Corrección de la dosisEs el método más común y más eficaz, y se basa en el principio de que todas las imágenes expuestas se exponen artificialmente a una cantidad uniforme de energía.La corrección de dosis también se divide en: la técnica autoconsistente (corrección física) y el método de corte geométrico.Técnica autoconsistente (corrección física): relativamente precisos, pero intensivos desde el punto de vista computacional para los diseños de circuitos integrados a gran escala;Método de corte geométrico: la distribución de la dosis de exposición calculada es más gruesa, pero el cálculo es muy rápido;
- Compensación del tamaño gráficoCompensa los efectos de la energía local alta o baja reduciendo o aumentando el tamaño de cada gráfico, y es adecuado para gráficos con repetición de ciclo simple.
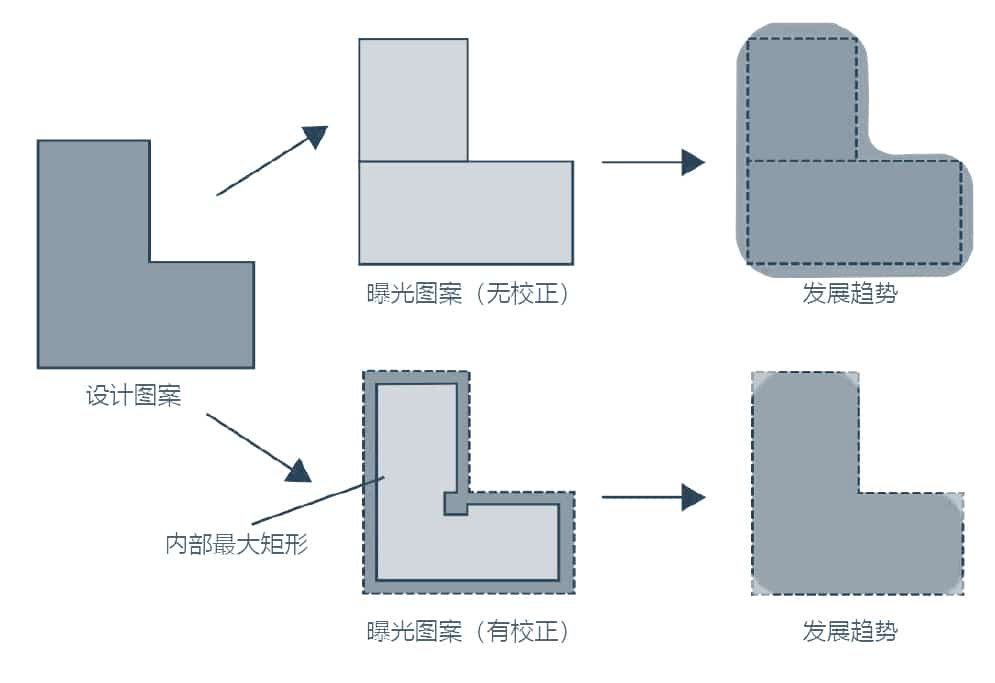
Compensación de la exposición de fondoEs adecuado para los sistemas de exposición de barrido de trama, en los que la distribución de energía se equilibra en todas las ubicaciones mediante la superposición de la energía de la segunda exposición, lo que elimina la necesidad de calcular la distribución de energía, pero posiblemente reduce el contraste de la imagen expuesta.
La forma más sencilla y eficaz de reducir el efecto de proximidad es aumentar la energía del haz de electrones y reducir el grosor de la fotoresina del haz de electrones.Sin embargo, hay que tener en cuenta el potencial de daño y sobrecalentamiento del sustrato debido a la elevada energía del haz de electrones.

Aplicaciones
Máscaras de alta precisión: la litografía por haz de electrones tiene una amplia gama de aplicaciones en el campo de la fabricación de máscaras de alta precisión para circuitos integrados debido a su alta resolución y a su tipo de escritura directa.
Optoelectrónica, como la creación de prototipos de chips electrónicos y optoelectrónicos y la producción de pequeños lotes, la producción de pequeños lotes en las industrias de rejillas de difracción, óptica binaria, microóptica y nanoóptica (conjuntos de microlentes, guías de ondas ópticas) y superlentes de superficie, la personalización de dispositivos optoelectrónicos especiales.
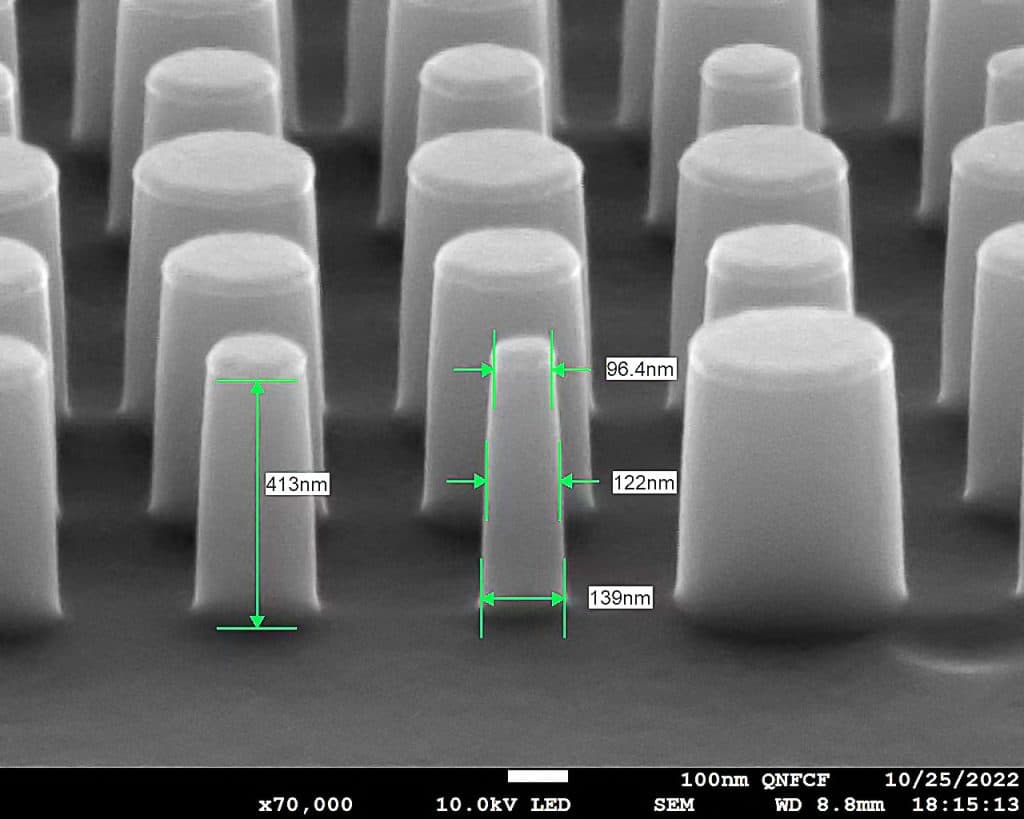
Ofrecemos Litografía por haz de electrones / Servicios de diseño de procesamiento de microestructuras y nanoestructurasno dude en dejarnos un comentario.
Micro y nanoprocesamiento | Introducción a la deposición de películas finas
微纳加工 | 薄膜沉积工艺介绍 目录 什


