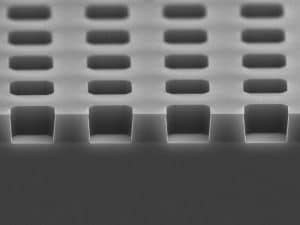
マイクロ・ナノプロセス|薄膜プロセス概論
薄膜形成(コーティング)とは?
薄膜形成プロセスの種類とメリット・デメリットの比較
物理的気相成長法(PVD)とは、真空下で原料を加熱し、原料の表面から原子や分子を放出させ、基板上に薄膜を成長させる方法である。物理蒸着は、真空電子ビーム蒸着や抵抗蒸着、スパッタコーティング、アークプラズマ蒸着、イオンコーティング、分子線エピタキシーなどが主な方法で、AEMDの電子ビーム蒸着装置やスパッタリング装置はいずれも物理蒸着である。
もの物理的気相成長法(PVD) は、熱蒸着とプラズマスパッタリング成膜の2つに大別される。Thermal evaporation deposition(熱蒸着)です。抵抗蒸発成膜, ,電子ビーム蒸着(a)新システムの重要な特徴として、次のようなものがあります。プラズマスパッタリングデポジション:: 以下のとおりです。DCスパッタリング、RFスパッタリング、マグネトロンスパッタリング、イオン性PVD.
CVD(Chemical Vapour Deposition)とは、気体状の物質を固体表面で化学反応させ、その表面に堆積させることで安定した固体膜を形成するプロセスです。1)反応ガスの基板表面への拡散、2)反応ガスの基板表面への吸着、3)基板表面で発生した気相副生成物の表面からの剥離、4)残された反応物からのクラッド層の形成、という4つの主要な重要段階がある。プラズマやレーザーアシストなどの技術を用いると、化学反応が大幅に促進され、より低温での成膜が可能になる。
化学気相成長法(CVD)低圧(LPCVD)、大気圧(APCVD)、原子層堆積(ALD)、プラズマエンハンスト(PECVD)、有機金属化合物(MOCVD)を含む
原子層堆積法(ALD)化学気相成長法(CVD)の一種で、基板表面に物質を1層ずつ原子膜状にメッキしていく方法である。原子層蒸着は、通常の化学蒸着と類似しています。しかし、原子層堆積法では、新しい原子の層の化学反応は前の層と直接関連し、この方法では1回の反応につき1層の原子しか堆積させることができない。
各種成膜方法のメリット・デメリットの比較
| クラフトマンシップ | アトミックレイヤーデポジション (ALD)です。 | 物理的気相成長(Physical Vapour Deposition (PVD) | 化学気相成長(Chemical Vapour Deposition (CVD) | 低圧化学気相成長法(Low Pressure Chemical Vapour Deposition (LPCVD炉心管) |
|---|---|---|---|---|
| 成膜原理 | 化学的表面飽和 反応-沈殿 | エバポレーション-コンソリデーション | 気相反応 - 蒸着 | 低圧化学気相成長法(Low Pressure Chemical Vapour Deposition (ストーブ&チューブ) |
| 成膜プロセス | 層流成長 | 核生成成長 | 核生成成長 | 核生成成長 |
| テラスの広さ | エクセレント | 一般 | 良い | 良い |
| 成膜速度 | あたまがわるい | クイック | クイック | より低速 |
| 成膜温度 | 低い (<500°C) | 低い | ハイ | より高い |
| 均質性 | エクセレント 0.07 - 0.1nm | 一般 5nm程度 | より良い 0.5 - 2nm | より良い |
| 厚み制御 | 反応サイクル数 | 成膜時間 | 成膜時間 気相分圧 | 成膜時間 ガス比 |
| 原材料名 | 不純物が少なく、均一 | 無添加 | 不純物を含みやすい | 無添加 |
フィルムの種類と適用シーン
| フィルムの種類 | 分類 | 薄膜形成材料 | アプリケーション |
| 半導体 | ポリシリコン | SiH4 (シラン) | MOSのゲート、高抵抗など。 |
| 単結晶シリコン | SiH₂Cl₂(ジクロロシラン; DCS) | パワーデバイス用単結晶エピタキシャル層など。 | |
| SiHCl3 (トリクロロシラン; TCS) | |||
| SiCl4(塩化ケイ素;シルテット) | |||
| アモルファスシリコン | SiH4 (シラン) | α-Si太陽電池、ソース/ドレイントレンチ面積など。 | |
| 誘電品質 | Si02(二酸化珪素) | SiH4、O2 SiH4、N20 Si(OC2H5)4(テトラエトキシシラン)、O2/O3 | 最も広く使われている誘電体膜、STI、ゲート酸化膜、サイドウォール、PMD、IMD、レジスト、ハードマスクなど。 |
| Si3N4/SiN (窒化珪素) | SiH4、N2O、N2、NH3 C8H22N2Si [ ビス(tert-ブチルアミノ)シラン ]。 | エッチストップ層、ハードマスク、パッシベーション層など。 | |
| SiON (窒化ケイ素) | SiH4、N2O、N2、NH3 | 反射防止層、酸化膜グリル、ハードマスクなど。 | |
| PSG/BPSG (ホスホロシリケート/ホウケイ酸ガラス)。 | シラン、ボラン、フォスフォラン等 | PMD、パッシベーション層、など。 | |
| 低誘電率(Low-K)材料 | ポリイミド(PI)など | PMDのSiO2置換 | |
| High-K(高誘電率)材料 | Hf、O2、SiO2など。 | グリッドメディア層におけるSiO2の置き換え | |
| メタル 金属化合物 | W(タングステン) | WF6(六フッ化タングステン)、SiH4、H2 | 電気フィルム、光学フィルム、リジッドフィルム、耐食フィルム、コンタクトホール、スルーホール、ゲートなど。 |
| WSi2/TiSi2 /CoSix/NiSi | WF6、シランなど | ソース/ドレイン/ゲートのシリサイド層 | |
| チタン | Ti[N(CH3)2]4 [ テトラキス(ジメチルアミノ)チタン ]。 | バリア層、メタルグリルなど。 | |
| ティ | TiCl4 (塩化チタン) | ||
| タ・タ・ン | |||
| Au/Al/Cu | 金属層、金属グリッドなど |
を迅速に提供します。 薄膜形成 / マイクロ・ナノ構造プロセス設計サービス, お問い合わせの際は、お気軽にメッセージを残してください。


