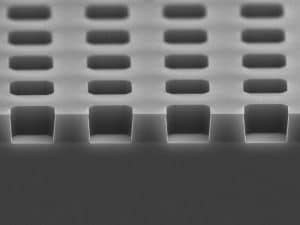
Micronanofabrication | Introduction aux procédés de dépôt de couches minces
Qu'est-ce que le dépôt de couches minces ?
Comparaison des types de procédés de dépôt de couches minces, avantages et inconvénients
Le dépôt physique en phase vapeur (PVD) est une méthode permettant de produire des films minces sur un substrat en chauffant un matériau source sous vide de sorte que des atomes ou des molécules s'échappent de la surface du matériau source.Les principales méthodes de dépôt physique en phase vapeur sont l'évaporation par faisceau d'électrons sous vide ou par résistance, le revêtement par pulvérisation, le revêtement par plasma d'arc, le revêtement ionique et l'épitaxie par faisceau moléculaire, etc. Le système d'évaporation par faisceau d'électrons et le système de pulvérisation de l'AEMD appartiennent au dépôt physique en phase vapeur.
questionDépôt physique en phase vapeur (PVD) qui peuvent être divisés en deux catégories principales, le dépôt par évaporation thermique et le dépôt par pulvérisation plasma.Dépôt par évaporation thermique :Dépôt par évaporation résistiveetDépôt par évaporation par faisceau d'électrons. ;dépôt par pulvérisation plasma: :Pulvérisation DC, pulvérisation RF, pulvérisation magnétron, ionisation PVD.
Le dépôt chimique en phase vapeur (CVD) est un procédé qui permet à des substances gazeuses de réagir chimiquement à la surface d'un solide et de s'y déposer pour former un film solide stable.Il y a quatre étapes importantes : 1) la diffusion des gaz réactifs vers la surface du substrat ; 2) l'adsorption des gaz réactifs sur la surface du substrat ; 3) le détachement de la surface des sous-produits de la phase gazeuse produits sur la surface du substrat ; et 4) la formation d'une couche de revêtement à partir des réactifs laissés sur place. L'utilisation de techniques telles que le plasma et l'assistance laser peut faciliter considérablement les réactions chimiques, ce qui permet d'effectuer le dépôt à des températures plus basses.
Dépôt chimique en phase vapeur (CVD)Y compris la basse pression (LPCVD), la pression atmosphérique (APCVD), le dépôt par couche atomique (ALD), le dépôt par plasma (PECVD) et le dépôt de composés organo-métalliques (MOCVD).
Dépôt de couches atomiques (ALD)Il s'agit d'un type de dépôt chimique en phase vapeur (CVD), une méthode qui permet de déposer des substances sur la surface d'un substrat, couche par couche, sous la forme d'un film atomique unique. Le dépôt par couche atomique présente des similitudes avec le dépôt chimique ordinaire. Cependant, lors du dépôt de couches atomiques, la réaction chimique du nouveau film atomique est directement associée à la couche précédente, ce qui fait que cette méthode ne dépose qu'une seule couche d'atomes par réaction.
Comparaison des avantages et des inconvénients des différentes méthodes de dépôt de couches minces
| arts et artisanat | dépôt par couche atomique (ALD) | Dépôt physique en phase vapeur (PVD) | dépôt chimique en phase vapeur (CVD) | Dépôt chimique en phase vapeur à basse pression (tubes de four LPCVD) |
|---|---|---|---|---|
| Principe de dépôt | Saturation chimique de la surface Réaction-Dépôt | Évaporation-solidification | Dépôt par réaction en phase gazeuse | Dépôt chimique en phase vapeur à basse pression (Type de tube de four) |
| processus de sédimentation | croissance stratifiée | nucléation | nucléation | nucléation |
| Couverture des étapes | talentueux | habituel | (d'un couple non marié) être proche | (d'un couple non marié) être proche |
| taux de sédimentation | lentement | tranchant (des couteaux ou de l'esprit) | tranchant (des couteaux ou de l'esprit) | plus lent |
| température de dépôt | Faible (<500°C) | baisser (la tête) | votre (honorifique) | plus important |
| uniformité | talentueux 0,07 - 0,1nm | habituel 5 nm environ | de préférence 0,5 - 2nm | meilleur |
| Contrôle de l'épaisseur | Nombre de cycles de réaction | temps de dépôt | temps de dépôt pression partielle de la phase gazeuse | temps de dépôt taux de gaz |
| ingrédient | Uniformité avec peu d'impuretés | non falsifié | Sujet aux impuretés | non falsifié |
Types de films et scénarios d'application
| Type de film | catégorisation | Matériaux de dépôt de couches minces | appareil |
| l'industrie des semi-conducteurs | silicium polycristallin (utilisé en électronique) | SiH4 (silane) | Portes MOS, résistances de grande valeur, etc. |
| silicium monocristallin | SiH₂Cl₂ (Dichlorosilane ; DCS) | Couches épitaxiales monocristallines pour dispositifs de puissance, etc. | |
| SiHCl3 (trichlorosilane ; TCS) | |||
| SiCl4 (Chlorure de silicium ; Siltet) | |||
| silicium amorphe | SiH4 (silane) | Cellules solaires α-Si, zone du canal source/drain, etc. | |
| diélectrique | Si02 (dioxyde de silicium) | SiH4, O2 SiH4, N20 Si(OC2H5)4 (tétraéthoxysilane), O2/O3 | Les films diélectriques les plus utilisés, les STI, les oxydes de grille, les parois latérales, les PMD, les IMD, les couches barrières, les masques durs, etc. |
| Si3N4/SiN (nitrure de silicium) | SiH4, N2O, N2, NH3 C8H22N2Si [ Bis(tert-butylamino)silane ] | Arrêts de gravure, masques durs, couches de passivation, etc. | |
| SiON (Nitrure de silicium) | SiH4, N2O, N2, NH3 | Couche antireflet, couche d'oxyde de grille, masque dur, etc. | |
| PSG/BPSG (verre phosphore-silice/boron-phosphore-silice) | Silanes, boranes, phosphanes, etc. | PMD, couche de passivation, etc. | |
| Matériaux à faible K (faible diélectrique) | Polyimide (PI), etc. | Remplacement du SiO2 dans le PMD | |
| Matériaux à haute température (diélectrique élevé) | Hf, O2, SiO2, etc. | Remplacement du SiO2 dans la couche de support de la grille | |
| huile de cuisson composé métallique | W (tungstène) | WF6 (hexafluorure de tungstène), SiH4, H2 | Films électriques, films optiques, films rigides, films résistants à la corrosion, trous de contact, trous de passage, portes, etc. |
| WSi2/TiSi2 /CoSix/NiSi | WF6, silane, etc. | Couche de silicium sur la source/drain/porte | |
| TiN | Ti[N(CH3)2]4 [ tétrakis(diméthylamino)titane] | Couches barrières, grilles métalliques, etc. | |
| Ti | TiCl4 (chlorure de titane) | ||
| Ta/TaN | |||
| Au/Al/Cu | Couches métalliques, grilles métalliques, etc. |
Lecture approfondie :
- Nanofabrication - Vue d'ensemble
- Micronanofabrication | Lithographie - Lithographie par nano-impression
- Micronanofabrication | Lithographie - Faisceau d'ions focalisés FIB
- Nanofabrication | Lithographie - Lithographie par faisceau d'électrons
- Nanofabrication | Lithographie - Lithographie optique
- Traitement micro-nano | Gravure
- Nanofabrication | Préparation de couches minces - Epitaxie
- Micronanofabrication | Préparation de couches minces - PVD
- Nanofabrication | Préparation de couches minces - CVD
Nous offrons un service rapide Dépôt de couches minces / Traitement des micro et nanostructures Services de conception, N'hésitez pas à laisser un commentaire.


