
Traitement micro-nano丨Lithographie par faisceau d'électrons (EBL) Introduction à la technologie
Qu'est-ce que la lithographie par faisceau d'électrons ?
La lithographie par faisceau d'électrons (e-beam lithography ; EBL) est une sorte de lithographie sans masque, qui utilise des électrons focalisés de très courte longueur d'onde pour agir directement sur la surface de la résine photosensible sensible aux électrons (resist) afin de cartographier la formation de micro-nanostructures conformément à la conception du motif. Le système EBL présente les avantages d'une résolution ultra-élevée (taille ultime <10nm) et d'une grande souplesse d'utilisation (il est possible d'écrire directement sans masque), mais en raison de la faible efficacité de l'exposition et de la complexité du contrôle, l'EBL est davantage utilisée pour la production de masques de photolithographie, de prototypes de principe avancés et pour la recherche et le développement scientifiques à l'échelle nanométrique.
Historique du développement
- En 1958, des chercheurs du Massachusetts Institute of Technology (MIT) aux États-Unis ont utilisé pour la première fois la contamination par le carbone induite par les électrons pour former un masque de gravure permettant de produire des structures graphiques bidimensionnelles à haute résolution.
- L'exposition au faisceau d'électrons a été utilisée pour fabriquer des structures de 100 nm dès 1965
- 1968 Le PMMA est utilisé comme résine photosensible pour faisceau d'électrons.
- Dispositif à ondes acoustiques de surface de 0,15um fabriqué en 1970 à partir de PMMA
- 1972 Des lignes métalliques en aluminium d'une section transversale de 60x60nm ont été réalisées sur une surface de silicium par lithographie par faisceau d'électrons.
Dans les années 1980, on pensait généralement que l'exposition optique avait fait son temps et que la lithographie par faisceau d'électrons était l'alternative la plus prometteuse ; cependant, plus de 30 ans plus tard, la lithographie par faisceau d'électrons n'est toujours pas un substitut à l'exposition optique. Le développement des deux technologies de lithographie a progressivement formé un modèle complémentaire, et l'on pense que ce modèle restera longtemps en place.
fondement théorique
La photolithographie est l'utilisation de l'irradiation lumineuse des polymères pour produire des changements dans la formation des graphiques, l'exposition optique de la résolution des limites de la longueur d'onde de la lumière, afin d'améliorer la résolution de l'exposition optique, le choix de l'onde lumineuse est passé par un raccourcissement continu du développement du processus de la ligne G à la ligne I, à l'ultraviolet profond, à l'ultraviolet extrême.
Les faisceaux d'électrons sont essentiellement des particules chargées avec une longueur d'onde selon la théorie de la dualité onde-particule :

Systèmes d'exposition aux faisceaux d'électrons
- Une source d'électrons chauds est une cathode chauffée à une température suffisamment élevée pour que les électrons présents dans le matériau de la cathode puissent acquérir suffisamment d'énergie cinétique pour franchir la barrière de potentiel de la fonction de travail du métal du canon à électrons et être émis pour former un faisceau d'électrons.
- Une source d'émission de champ est une source d'électrons formée par le renforcement d'un champ électrique qui permet aux électrons de traverser une barrière de potentiel. La focalisation et la déviation du faisceau d'électrons émis par la source d'émission d'électrons s'effectuent dans la colonne d'électrons, qui se compose d'une série de lentilles électroniques, de diaphragmes, de déflecteurs et d'autres dispositifs. Les électrons sont formés par le diaphragme, convergent en un point de faisceau par la lentille électronique et peuvent être exposés sur la table grâce au système de déviation.

Indicateurs importants pour les systèmes d'exposition au faisceau d'électrons
- Diamètre minimal du faisceau :affecte directement la taille minimale du motif exposé. Des diamètres de spot plus petits peuvent être obtenus en ajustant les mesures suivantes : ① Réglage de la tension d'accélération aussi élevée que possible ② Adoption d'une ouverture de diaphragme plus petite ③ Adoption d'une petite distance de travail ④ Réglage d'un petit champ de balayage ⑤ Réglage d'une petite taille de pas d'exposition
- Tension d'accélération :Généralement 10~100kv Plus la tension d'accélération est élevée, plus la résolution est élevée, plus l'effet de voisinage produit par l'exposition est faible et plus la résine peut être exposée en épaisseur.
- Flux de faisceaux d'électrons :La vitesse d'exposition maximale est limitée par la fréquence de balayage, et la tache du faisceau sera plus grande pour les courants de faisceau importants.
- Vitesse de numérisation :Plus la vitesse de balayage est élevée, plus la vitesse d'exposition est élevée, exprimée en fréquence (par exemple 50 MHz).
- Taille du champ de balayage :Un grand champ de balayage permet à la plupart des graphiques exposés de l'être à l'intérieur du champ de balayage, ce qui évite les erreurs causées par le recoupement du champ de balayage.
- Précision du mouvement de la table, précision de l'enregistrement, précision de l'assemblage sur le terrain, etc.
Classification des méthodes d'exposition au faisceau d'électrons
Selon le mode de travail, on distingue
Exposition projetée (masque requis) et exposition directe à l'écriture (sans masque requis)
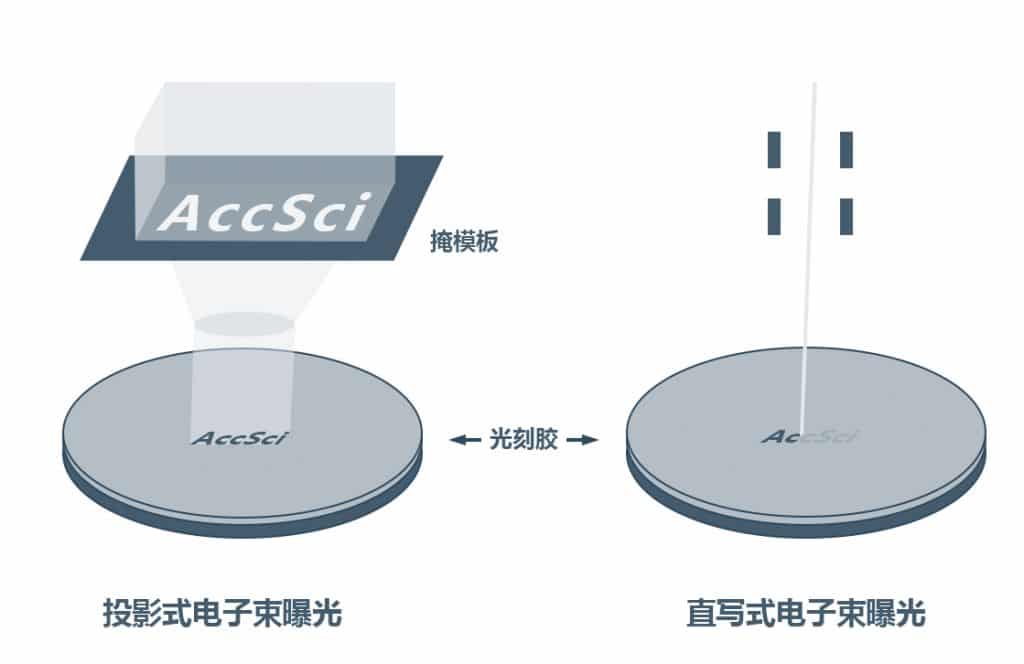
Divisé par la méthode de balayage
Numérisation matricielle et numérisation vectorielle.
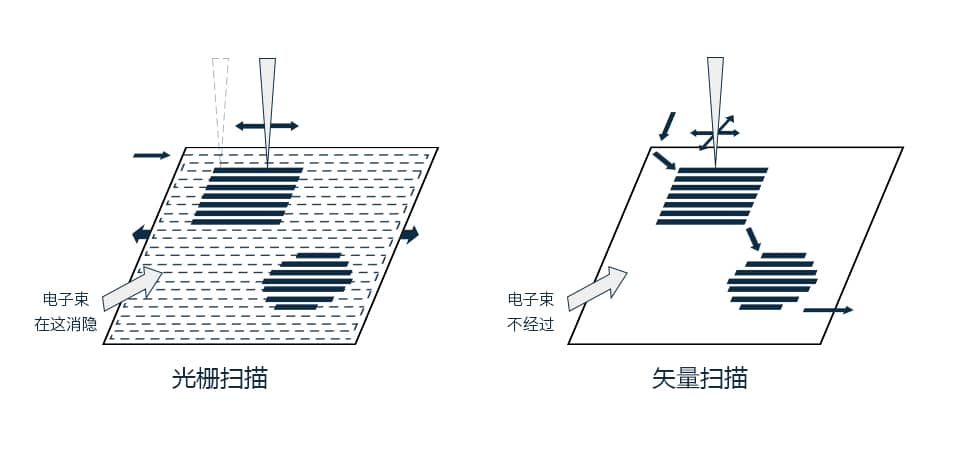
- numérisation de tramesUn faisceau circulaire gaussien est utilisé, et le faisceau d'électrons est balayé en continu point par point sur l'ensemble du champ de balayage, et l'exposition graphique est réalisée en contrôlant l'activation et la désactivation de l'obturateur (porte de faisceau).L'avantage du balayage de trame est la simplicité du contrôle et l'absence de nécessité de contrôler le système de déviation. L'inconvénient est la faible productivité. En raison de la faible portée du champ de balayage, l'exposition doit être effectuée en même temps que le mouvement de la table de la pièce.
- Balayage vectorielLes avantages du balayage vectoriel sont une grande efficacité d'exposition, le balayage des expositions uniquement dans les zones graphiques, la réduction du temps passé par l'objectif dans les zones non graphiques et la possibilité d'utiliser des faisceaux rectangulaires variables. L'inconvénient est que le système de contrôle est complexe, car le balayage vectoriel doit contrôler le déflecteur, contrairement au balayage matriciel avec un déflecteur fixe.
Selon la forme du faisceau d'électrons, on distingue les catégories suivantes
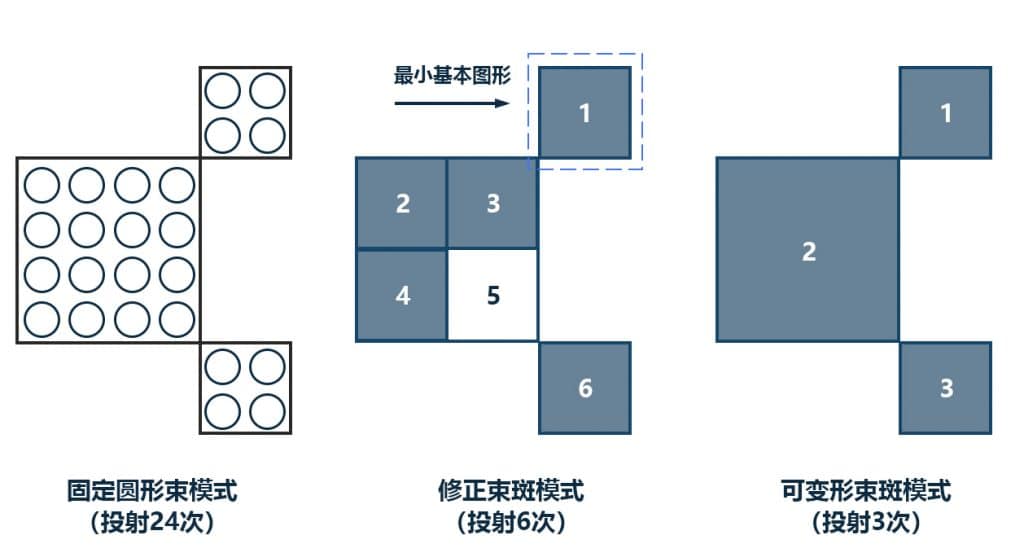
En mode de balayage vectoriel, le temps d'exposition d'un graphique est lié au nombre de projections de la tache du faisceau, leEn mode spot à faisceau gaussien fixe (faisceau circulaire), nous devons effectuer 24 projections.
Afin d'accélérer la vitesse d'exposition, le motif peut être décomposé en une combinaison du plus petit motif de base, le plus petit motif de base étant la forme de la tache du faisceau d'électrons. Seules 6 projections sont nécessaires dans ce motif de spot de faisceau modifié.
Cependant, dans la pratique, les graphiques ne sont pas statiques et la forme de base de la tache du faisceau doit être fréquemment modifiée, d'où la nécessité d'une méthode de projection plus flexible. Une méthode de projection plus flexible est donc nécessaire. Un mode de spot de faisceau variable peut être appliqué au cas de divers graphiques. Comme le montre la figure ci-dessous, en mode spot variable, le spot du faisceau d'électrons peut être adapté au motif spécifique, en changeant la forme de base du spot et en réduisant le nombre de projections à trois.
Introduction aux photorésines à faisceau d'électrons
résine photosensible (gravure au laser utilisée en microélectronique) (Photoresist ; également connu sous le nom de résine photosensible) est un matériau en couche mince résistant à la gravure dont la solubilité est modifiée par l'irradiation ou le rayonnement de sources lumineuses telles que la lumière ultraviolette, le laser à excimère, le faisceau d'électrons, le faisceau d'ions et les rayons X.
Les photorésines à faisceau d'électrons sont généralement classées en photorésines positives et négatives.qui peuvent être divisés en fonction de la personne qui domine la réaction de réticulation ou la rupture de la liaison chimique après l'irradiation de la résine photosensible.Les propriétés positives et négatives de la résine photosensible ne sont pas absoluesPar exemple, à une dose d'exposition 10 fois supérieure à la dose normale d'un adhésif PMMA positif au faisceau d'électrons, l'adhésif de la zone exposée se carbonise, ce qui produit un résidu pendant le processus de développement, et ses propriétés peuvent être utilisées comme adhésif négatif.
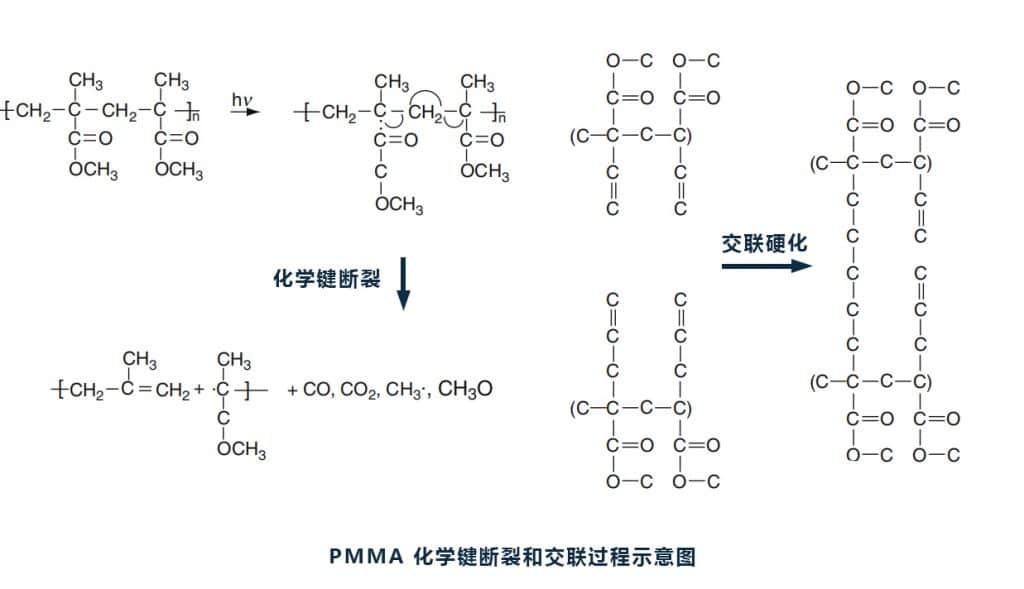
Photorésine positive (gel positif) : les réactions de rupture des liaisons chimiques dominent dans la photorésine dans la zone d'exposition et sont facilement solubles dans le révélateur.
Photorésine négative (adhésif négatif) : zone d'exposition de la photorésine dans la réaction de réticulation dominée par la polymérisation de petites molécules de réticulation en grosses molécules, difficiles à dissoudre dans le révélateur.

Paramètres clés des résines photosensibles
Comme pour les photorésines UV, nous sélectionnons ou évaluons généralement une photorésine pour une utilisation dans un processus en examinant quatre paramètres : la sensibilité, le contraste, la résolution et la résistance à la gravure.
- Sensibilité :Plus la sensibilité de la résine photosensible est élevée, plus la dose d'exposition nécessaire (irradiation) est faible. La sensibilité est influencée par la capacité des électrons en keV (ou la tension d'accélération en kV), les matériaux du substrat, les conditions du processus, l'utilisation du révélateur et d'autres facteurs.
- Contraste :Un contraste plus élevé permet d'obtenir des parois latérales plus raides, des marges de traitement plus importantes, une meilleure résolution, des structures à rapport d'aspect plus élevé qui sont moins sensibles aux effets de proximité et une plus grande densité de motifs. Un faible contraste ne convient qu'à la lithographie 3D en niveaux de gris.
- Résolution :définit la taille de la plus petite caractéristique pouvant être obtenue ou la distance minimale entre deux structures.
- Résistance à la gravure :Si un processus de gravure s'avère nécessaire par la suite, il convient de choisir une résine photosensible qui conserve l'intégrité de ses propriétés pendant les processus de gravure chimique (humide) et physique (sèche).
Il est également nécessaire de prendre en considération la sélection d'une résine photosensible appropriée en combinaison avec les caractéristiques positives et négatives de la résine photosensible, la tolérance du processus, l'adhérence, la fluidité thermique, l'effet de gonflement, la durée de stockage et d'autres paramètres.
Résines photosensibles couramment utilisées
Différentes photorésines sont nécessaires pour différentes applications, et cette section se concentre sur les photorésines à faisceau d'électrons centralisé couramment utilisées dans les expériences, y compris le PMMA positif, le ZEP-520A, l'AR-P 6200 (SCAR62) et le HSQ négatif.
PMMA (caoutchouc positif)
Le PMMA (poly-méthacrylate de méthyle, polyméthacrylate de méthyle) est un polymère, également connu sous le nom d'acrylique ou de plexiglas, qui est actuellement la résine photosensible par faisceau d'électrons la plus populaire. La poudre de PMMA 5% ~ 10% et le chlorobenzène ou l'anisole (moins toxique, 2-4%) peuvent être mélangés pour former une résine photosensible par faisceau d'électrons. Photorésine.
- Bon marché, durable et facile à utiliser
- Résolution et contraste très élevés
- faible sensibilité
- Faible résistance à la gravure à sec (favorable au décollement par pelage, ne convient pas au transfert de motifs par gravure directe).
- La sensibilité augmente lorsque la masse moléculaire relative diminue, avec des masses moléculaires relatives typiques de 495 kg/mol et 950 kg/mo pour le PMMA.
- Le contraste et la sensibilité peuvent être modulés en faisant varier la proportion de MIBK dans le mélange de révélateur (MIBK:IPA), la sensibilité augmentant avec la proportion de MIBK dans le révélateur et le contraste inversement.
Zep-520A (caoutchouc positif)
Le Zep-520A, la résine photosensible la plus répandue dans le commerce, a été développé par Nippon Zeon au Japon en tant qu'adhésif modifié par un anneau de PMMA et de benzène, constitué d'un copolymère d'α-chlorométhacrylate et d'α-méthylstyrène destiné à remplacer le PMMA.
- Haute résolution et contraste élevé, avec une résolution élevée comparable à celle du PMMA (structure graphique de 10 à 30 nm possible) et un contraste élevé
- Sensibilité élevée, supérieure à celle du PMMA (3 à 5 fois)
- Très résistant à la gravure à sec, 5 fois plus résistant à la gravure à sec que le PMMA.
- Cher avec une garantie d'un an.
- Pour les taux de classification très élevés (inférieurs à 10 nm), il peut être préférable d'utiliser du PMMA.
- Le ZEP-520A n'est pas facile à enlever après l'exposition, le développement et la cuisson du film ferme, et le ZDMAC est généralement utilisé pour enlever l'adhésif.
AR-P 6200 (CSAR62) (caoutchouc positif)
- Résolution ultra-haute (<10nm)
- Sensibilité élevée, la sensibilité peut être ajustée en sélectionnant le révélateur approprié.
- Rapport de contraste élevé (>15)
- Rapport hauteur/largeur élevé (jusqu'à 20:1)
- Il présente une bonne stabilité des processus et une résistance à la gravure à sec deux fois supérieure à celle du PMMA ;
- Bonne adhérence avec le substrat, pas de phénomène de dégommage ni de fissuration ;
- Le module d'Young est faible et sujet à l'affaissement, au collage et au renversement ;
- Le point de fusion bas produit une fusion de la résine ;
- Les surfaces graphiques sont sujettes au rétrécissement
HSQ (gel négatif)
- Très haute résolution (<10nm)
- Faible sensibilité et longs temps d'exposition ;
- Se développe par réaction chimique (le HSQ non exposé réagit avec le révélateur NH4OH ou NaOH dilué pour former du H2), et non par dissolution, avec une bonne stabilité du processus après le développement ;
- Bonne performance d'observation au microscope électronique sans placage d'or ;
- C'est un bon matériau de masque pour la gravure du silicium ;
- La durée de conservation est courte, avec un cycle de stockage de seulement 6 mois. Le HSQ (H-SiOx) sous forme de poudre a une durée de conservation plus longue.
- Les conditions de stockage sont difficiles, le colloïde est facilement oxydé lorsqu'il est exposé à l'air et le durcissement de la gelée se produit, il doit être stocké à basse température (5°C) dans un récipient scellé ;
- Contraste extrêmement élevé et facilité de préparation des structures à haut rapport d'aspect avec des profils abrupts ;
- Il s'agit d'une résine photosensible télescopique qui présente une bonne verticalité des bords de ligne après développement ;
- Bonne adhérence, bonne résistance, pas facile à casser ;
effet de proximité
L'exposition par faisceau d'électrons de l'effet de voisinage, c'est-à-dire lorsque les deux motifs d'exposition sont proches l'un de l'autre, en raison de la diffusion des électrons dans la résine photosensible et le substrat par rapport à la direction d'incidence originale, ce qui fait que l'original ne devrait pas être exposé aux régions voisines, et que certaines devraient être exposées à la région et pas suffisamment, ce qui entraîne une distorsion du motif d'exposition. Cela entraîne une réduction du contraste, une dégradation de la résolution et d'autres problèmes.
Méthode d'étalonnage
- correction de la doseLe principe est de faire en sorte que tous les graphiques d'exposition reçoivent une énergie d'exposition uniforme et cohérente de la part de l'homme.La correction de la dose est également divisée en deux catégories : les techniques autoconsistantes (correction physique) et les méthodes de coupe géométrique.Techniques d'autoconsistance (corrections physiques)La conception de circuits intégrés à grande échelle est plus précise, mais elle nécessite des calculs intensifs ;Méthode de découpe géométrique : la distribution de la dose d'exposition calculée est approximative, mais le calcul est très rapide ;
- Compensation de la taille des graphiquesL'effet d'une énergie localisée élevée ou faible est compensé par la réduction ou l'augmentation de la taille de chaque graphique, et convient aux graphiques avec de simples répétitions cycliques.
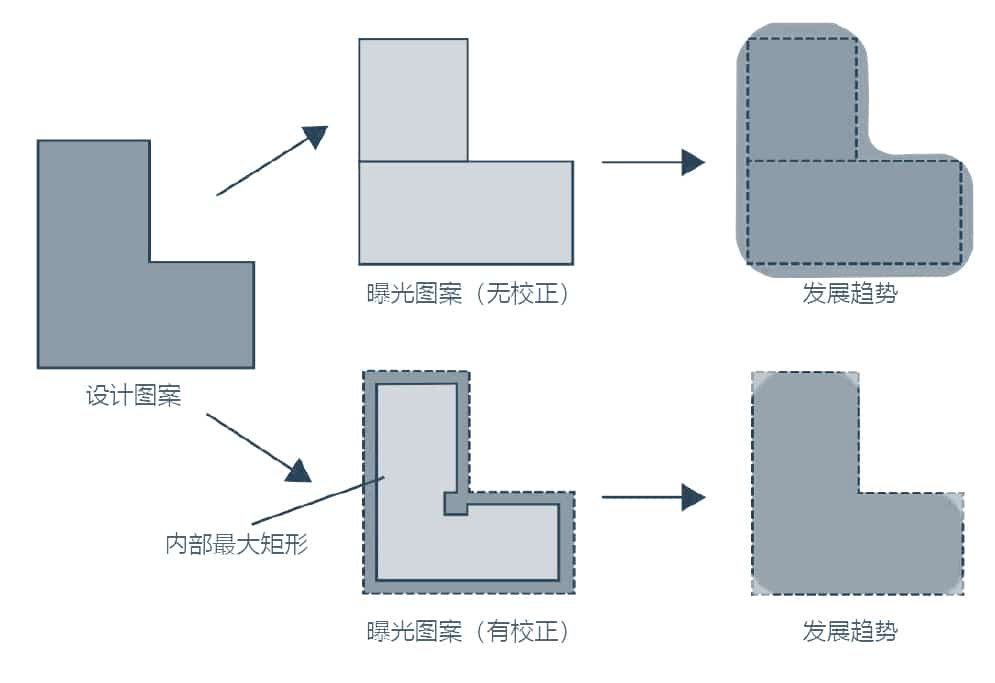
Compensation de l'exposition à l'arrière-planIl convient aux systèmes d'exposition à balayage de trame, dans lesquels la distribution d'énergie est égalisée à tous les endroits en superposant l'énergie de la deuxième exposition, sans qu'il soit nécessaire de calculer la distribution d'énergie, mais le contraste des graphiques exposés peut être réduit.
Le moyen le plus simple et le plus efficace de réduire l'effet de proximité est d'augmenter l'énergie du faisceau d'électrons et de réduire l'épaisseur de la résine photosensible du faisceau d'électrons.Toutefois, il faut tenir compte du risque d'endommagement et de surchauffe du substrat en raison de l'énergie élevée du faisceau d'électrons.

appareil
Masque de haute précision : la lithographie par faisceau d'électrons a un large éventail d'applications dans le domaine de la fabrication de masques de haute précision pour les circuits intégrés en raison de ses caractéristiques de haute résolution et d'écriture directe.
Le domaine de l'optoélectronique, tel que le prototypage de puces électroniques et optoélectroniques et la production de petites séries, les réseaux de diffraction, l'optique binaire, la micro- et la nano-optique (réseaux de microlentilles, guides d'ondes optiques), les lentilles à ultra-surface et d'autres industries de production de petites séries, les dispositifs optoélectroniques spéciaux sur mesure.
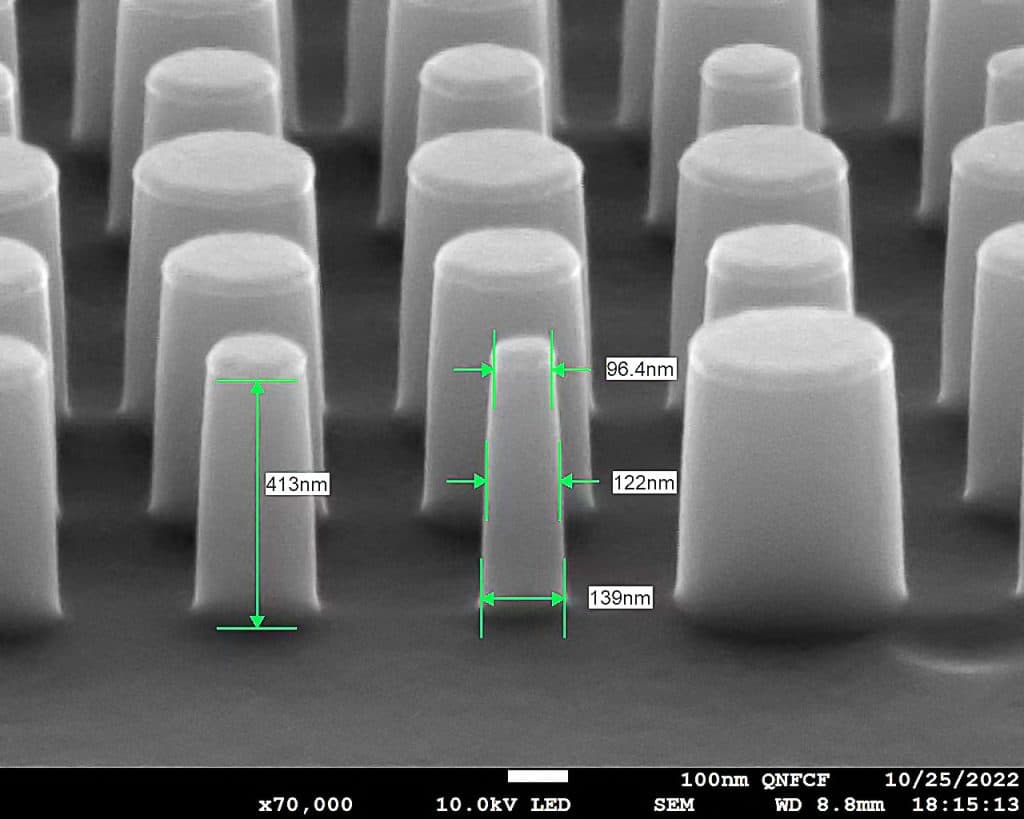
Nous proposons Services de conception pour la lithographie par faisceau d'électrons et le traitement des micro et nanostructuresN'hésitez pas à laisser un message.
Micro-nano-transformation | Fabrication de dispositifs électroluminescents en polymère
Micro-Nano Processing | AIE Polymer Luminescent Device Fabrication de dispositifs luminescents Micro-Nano Luminescent Devices
Introduction aux puces microfluidiques丨Matériaux couramment utilisés et méthodes de traitement des préparations
Introduction aux puces microfluidiques丨Commonly Used Materials and Preparation and Processing Methods Catalogue What
Micro-Nano Processing | Introduction au dépôt de couches minces
Micro-Nano Processing | Introduction aux procédés de dépôt de couches minces Catalogue Qu'est-ce que le dépôt de couches minces ?